
9.5 Іонне легування напівпровідників
Мікроелектронні структури можна одержувати за допомогою електронного і іонного променів (пучків). Таку технологію називають еліонною, а всі питання, що відносяться до її реалізації – еліонікою.
Еліонну технологію застосовують для різних видів оброблення –мікрофрезерування (гравіювання, літографії), мікрозварювання, різці, створення р-n-переходів і ін., а також для інтенсифікації фізико-хімічних процесів, що відбуваються на поверхні напівпровідникової або діелектричної підкладки, десорбції, полімеризації, конденсації, деструкції і т.д.
Найбільш широко використовують еліоніку в технології напівпровідникових ІМС для локального легування напівпровідників, заснованого на іонному впровадженні домішок.
Сутність іонного легування полягає в такому. Іони домішки, одержувані із спеціальних джерел, швидшають і фокусуються в електричному полі, потрапляють на підкладку, бомбардуючи її. Маючи велику енергію (10-103 кеВ), вони впроваджуються в поверхневий шар напівпровідника. При впровадженні в кристалічні гратки іони втрачають свою енергію внаслідок кулонівської взаємодії з атомами гратки, порушуючи або іонізуючи їх, так і через пружні (ядерних) зіткнення з атомами, в результаті яких утворюється велике число точкових дефектів гратки (міжвузлові атоми підкладки і вакансії). В загальному випадку при іонному впровадженні атоми домішки частково займають певне положення в гратках, а частково підпорядковане. Для впорядкування порушеної упровадженням іонів структури і тим самим створення електрично активної домішки підкладки піддають відпалу при температурі 650—700°С. Застосовують також лазерний відпал.
Таким чином, процес іонного легування складається з впровадження іонів і відпалу, одночасного з упровадженням або після нього.
Характерною особливістю іонного легування є те, що зміст упроваджених атомів домішки визначається не фізичними властивостями підкладки (як при дифузії), а умовами впровадження іонів і температурою відпалу, яка значно нижча, ніж при дифузії.
Іонне легування створюється на установці, схема якої показана на рис. 9.4. Джерело іонів 1 складається з камери, призначеної для іонізації пари легуючих елементів, і екстрагуючого іони зонда. Іонізація проводиться у високочастотному або дуговому розряді. Початковими матеріалами для отримання іонів фосфору і бору, які в основному використовують при легуванні кремнію, є червоний порошкоподібний або кристалічний фосфор і галогеніди бору. Речовину у вигляді твердої фази завантажують в тигель джерела, а пари галогенідів поступають в джерело через натікач.
Екстраговані за допомогою негативно зарядженого зонда додатні іони концентруються і фокусуються в пучок з густиною до 100 А/м![]() . Під дією напруги прискорювальної системи 2 (20-200 кВ) іонні пучки набувають необхідної енергії, достатньо потужної для іонного впровадження.
. Під дією напруги прискорювальної системи 2 (20-200 кВ) іонні пучки набувають необхідної енергії, достатньо потужної для іонного впровадження.
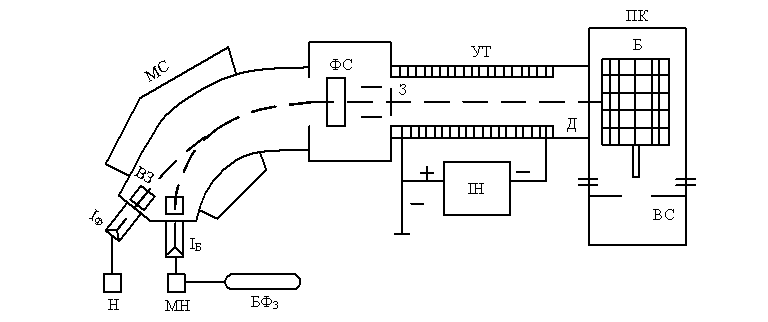
Рисунок 9.4 – Схема установки іонного легування напівпровідників
Магнітний мас-сепаратор 3 служить для виділення іонів потрібної маси, що досягається розділенням руху частинок по різних траєкторіях у відповідності з їх масами під впливом магнітного поля. Сепарація за масами обумовлює високу чистоту легування.
Система сканування 4 забезпечує керування потоком іонів по поверхні підкладок, встановлених в багатопозиційному приймачі іонів 5. Щоб уникнути зіткнень іонів при русі в установці підтримується вакуум (54·10-5 – 14·10-4 Па).
Установки даного типу забезпечують отримання легованих тонких шарів кремнію з глибиною залягання р-n-переходів 0,2—0,4 мкм, для чого необхідна доза іонного легування складає 10 –15 см-2, причому упровадження іонів здійснюється як в умовах нагріву підкладки, так і при кімнатній температурі з подальшим відпалом.
Ефективність застосування іонного легування визначається багатьма чинниками, головними з яких є: розподіл пробігів упроваджених атомів, ступінь і характер безпорядковості гратки, локалізація атомів в кристалічних гратках і електричні властивості шарів після упровадження і відпалу.
Основні переваги іонного легування:
При цьому градієнт концентрації домішки в області р-n-переходу істотно більший, ніж у дифузійного профілю;
Недоліки іонного легування – складність технологічних установок і можливість утворення дефекного шару на поверхні підкладок.
Іонне легування використовують для створення біполярних транзисторів НВЧ-діапазону, МДН-транзисторів із затвором, що самопоєднується, діодів, високоомних резисторів і інших елементів напівпровідникових ІМС.