Дрейфовий планарно-епітаксійний n-p-n-транзистор.
Розрахунок дрейфового планарно-епітаксійного транзистора розглянемо на прикладі кремнієвого n+-p-n-n+-транзистора. Розподіл домішок в такому транзисторі подано на рис. 2.5, б, а його структура і топологія – на рис. 2.6.

Рисунок 2.5 – Розподіл домішок в кремнієвому n+-p-n-n+ планарно-епітаксійному транзисторі
Для створення n+-p-n-n+ структури в епітаксійну плівку n-типу, що вирощена на сильно легованій n+-підкладці, проводять локальну двостадійну дифузію акцепторної домішки (бора) з низькою поверхневою концентрацією для створення області бази p-типу. Потім проводять локальну двостадійну дифузію донорної домішки (фосфору) для формування області емітера n+-типу. Межі емітерного і колекторного р-n-перехдів виходять на поверхню пластини під пасивуючою плівкою діоксиду кремнію. Профіль дифузійного розподілу домішки в активній області структури задається виразами:
N(x) = N2(x) - N1(x) + N0 ;
N2(x) = N20exp(-k2x2) ;
N1(x) = N10exp(-k1x2) ;
де N20 – поверхнева концентрація донорної домішки (фосфору);
N10 – поверхнева концентрація акцепторної домішки (бору);
N0 – вихідна концентрація донорної домішки в високоомному епітаксійному шарі колектора.
Задано
1. Електрофізичні параметри шарів кремнію: концентрація легуючих домішок N20, N10, N0 ; концентрація донорної домішки в n+-підкладці Nп; час життя неосновних носіїв заряду в указаних шарах.
2. Геометричні розміри і топологія структури: глибина залягання емітерного хе і колекторного хк р-n-переходів, товщина вихідного епітаксійного n-шару хп, товщина підкладки ωп; довжина lе і ширина zе емітерної смужки; довжина lк і ширина zк колектора; розміри смужок базової металізації lб і zб. Будемо вважати, що всі зазори, які визначають відстані від краю емітера до металізації бази та від краю емітера до краю колектора, складають Δ.
3. Робоча напруга на колекторі Uк = -5 В, струм емітера Іе = 1 мА.
4. Температура Т = 300 К.
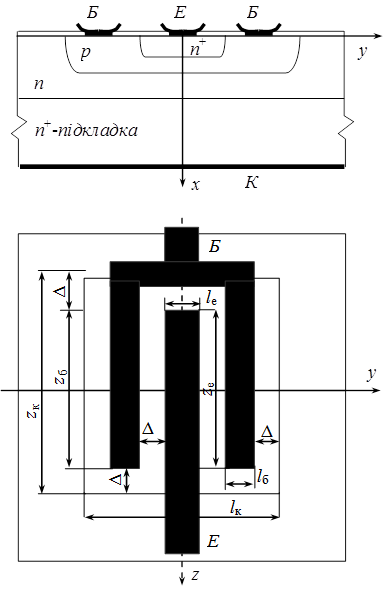
Рисунок 2.5 – Структура та топологія кремнієвого n+-p-n-n+ планарно-епітаксійного транзистора
Електрофізичні параметри і геометричні розміри транзистора зведені в табл. 2.3.
Рухливість основних і неосновних носіїв заряду зменшується зі зростанням сумарної концентрації іонізованих атомів легуючої домішки N+(х) і може бути розрахована за емпіричною формулою. Величина N+(x) визначається модулем суми позитивних і негативних іонізованих атомів легуючої домішки: N+(x) = N2(x) + N1(x) + N0.
Наведені в табл. 2.3 значення часу життя неосновних носіїв заряду в областях структури розраховані за умови, що рекомбінація електронів і дірок відбувається на рекомбінаційних пастках, утворених атомами золота, концентрація яких постійна по всій структурі і становить: Nt = NAu = 0,1 N0 = 1015 см-3.
При іншій концентрації золота час життя електронів і дірок може бути розраховано за формулами;
 ;
;

де σn1 = 6,3·10-15 см2 - переріз захоплення електрона;
σp2 = 11,5·10-15 см2 - переріз захоплення дірки на рекомбінаційну пастку;
υt ≈ 107 см/с - теплова швидкість носіїв заряду при 300 К.
Визначити
1. Значення констант к1 і к2, пов'язаних з параметрами дифузії домішки. Розрахувати розподіл домішок в структурі N2(x), N1(x), N(x), N+(x).
2. Електрофізичні параметри шарів напівпровідника: залежність рухливості носіїв заряду від координати; середні значення рухливості і дифузійної довжини неосновних носіїв заряду в шарах; середній питомий опір і питомий поверхневий опір кожного шару.
3. Параметри еквівалентної схеми транзистора для великого сигналу.
4. Параметри фізичної Т-подібної еквівалентної схеми транзистора, та h-параметри транзистора із спільною базою і спільним емітером.
5. Максимально допустимі параметри транзистора.
Порядок розрахунку
На додаток до даних табл. 2.3 приймемо концентрацію донорів в n+-підкладці Nп = 1020 cм-3 та товщину підкладки ωп = 200 мкм.
1. Невідомі коефіцієнти к1 і к2 можна знайти за умови, що результуюча концентрація домішки при х = хе і х = хк дорівнює нулю, тобто з ррозв’язку такої системи рівнянь:
 ;
;
При заданих значеннях N20, Nl0, N0, хе і хк наведені рівняння являють собою систему нелінійних алгебраїчних рівнянь щодо невідомих к1 і к2. Ця система може бути розв’язана методом послідовних наближень.
Таблиця 2.3 – Електрофізичні та геометричні параметри структури транзистора
| Параметр типу | Емітер п+- типу | База р-типу | Колектор n-типу |
|---|---|---|---|
| Поверхнева або вихідна концентрація домішки, см-3 | N20 = 1020 | N10 = 1018 | N0 = 1016 |
| Середня концентрація домішки в шарі (або ОНЗ), см-3 | 3,48 · 1019 | 4,79 · 1016 | 1016 |
| Середня концентрація ННЗ, см-3 | 5,63 | 4,09 · 103 (БА) | 1,96 · 104 |
| Середня рухливість ОНЗ, см2·В-1·с-1 | 72 | 234(БА) 49(БП) | 1050 |
| Середня рухливість ННЗ, см2·В-1·с-1 | 77,5 | 639(БА) | 384 |
| Середній коефіцієнт дифузії, см2·с-1 | 2,0 | 16,5 (БА) | 9,91 |
| Час життя ННЗ, с | 8,7·10-9 | 15,8·10-9 | 8,7·10-9 |
| Середня дифузійна довжина, см | 1,32·10-4 | 5,10·10-4 | 2,94·10-4 |
| Середня питома провідність шару, Ом-1·см-1 | 401 | 1,79 (БА) 13,9 (БП) | 1,68 |
| Середній питомий опір шару, Ом·см | 2,49·10-3 | 0,558 (БА) 7,21·10-2 (БП) | 0,595 |
| Питомий поверхневий опір шару, Ом/см2 | 13,8 | 5,58·103(БА) 257(БП) | 2380 |
| Товщина шару, см | 1,8·10-4 | 1·10-4 | 2,5·10-4 |
Примітка. БА – база активна, БП – база пасивна.
Знайдемо перше наближення для коефіцієнта к1. Концентрація N2(x), як випливає з рис. 2.5, дуже швидко спадає зі зростанням х, тому N2(хк) << N0, і прирівнявши до нуля два останні члени останнього рівняння, одержимо

Підставивши числові значення величин, що входять у праву частину цього рівняння, отримаємо, що к1(0) = 0,79268·108 см-2. Тепер можна знайти наближене значення коефіцієнта к2 за допомогою першого рівняння:

Значення коефіцієнта к1 можна уточнити, визначивши к1 з другого рівняння:

Розраховане за останньою формулою значення к1 дозволяє уточнити значення к2, знайдене раніше. Ітераційний процес закінчуємо, коли перші 4 – 5 знаків коефіцієнтів к1 і к2 перестануть змінюватися. Зазвичай для цього потрібно 5 – 7 ітерацій. Остаточно для даного прикладу маємо
к1 = 0,790966 · 108 см-2
к2 = 1,723686 · 108 см-2
Розподіл легуючих домішок в структурі N2(x), N2(x), N(x), розраховуємо за відповідними формулами. Результати обчислень наведені в табл. 2.4.
2. Власну концентрацію носіїв заряду в кремнії при Т = 300 К знаходимо з графіка (рис. 2.6)
Таблиця 2.4 – Розподіл домішок і рухливості носіїв заряду в заданій структурі| х, мкм | N2(x), см-3 | N1(x), см-3 | N(x), см-3 | N+(x), см-3 | μn, см2/(В·с) | μр, см2/(В·с) |
|---|---|---|---|---|---|---|
| 0 0,2 0,4 0,6 0,8 1,0 1,2 1,4 1,6 1,7 1,8 1,9 2,0 2,1 2,2 2,3 2,4 2,5 2,6 2,7 2,8 2,9 3,0 3,2 3,4 3,6 | 1,00Е20 9,33Е19 7,59Е19 5,38Е19 3,32 Е19 1,78Е19 8,36 Е18 3,41Е18 1,21Е18 6,86Е17 3,75 Е17 1,98Е17 1,01Е17 4,99Е16 2,38Е16 1,09 Н16 4,88Е15 2,09Е15 8,70Е14 3,49Е14 1,35Е14 5,06 Е13 1,83Е13 2,16Е12 2,22ЕП 1,99Е10 | 5,00Е18 4,84Е18 4,41Е18 3,76Е18 3,01 Е18 2,27Е18 1,60Е18 1,06Е18 6,60Е17 5,08Е17 3,85Е17 2,88Е17 2,11E17 1,53 Е17 1,09Е17 7,62Е16 5,25Е16 3,56Е16 2,38Е16 1,56Е16 1,01Е16 6,46Е15 4,05 Е15 1,52 Е15 5,34Е14 1,77Е14 | 9,50Е19 8,85 Е19 7,15Е19 5,00Е19 3,02Е19 1,56Е19 6,76Е18 2,36Е18 5,62Е17 1,88Е17 2,20Е12 -7,92Е16 -1,00Е17 -9,28 Е16 -7,49Е16 - 5,5ЕТ -3,76 Е16 -2,36 Е16 -1,29Е16 -5,31Е15 0 3,59Е15 5,97 Е15 8,48 Е15 9,46Е15 9,82Е15 | 1,05Е20 9,82Е19 8,03Е19 5,75Е19 3,62Е19 2,01Е19 9,97 Е18 4,48Е18 1,88Е18 1,20 Е18 7,71Е17 4,96Е17 3,23 Е17 2,13Е17 1,42Е17 9,71Е16 6,74Е16 4,77Е16 3,47Е16 2,59Е16 2,03Е16 1,65Е16 1,41 Е16 1,15 Е16 1,05Е16 1,02 Е16 | 72 73 74 76 81 89 105 134 188 229 280 342 415 496 581 667 750 827 895 952 998 1032 1058 1087 1100 1105 | 49 50 50 51 52 54 57 65 79 91 106 125 148 -175 204 235 266 295 321 344 362 376 387 400 404 406 |
Примітка. Символом Е позначено основу 10 перед показником степеня, наприклад, 1,05Е20 означає 1,05·1020.
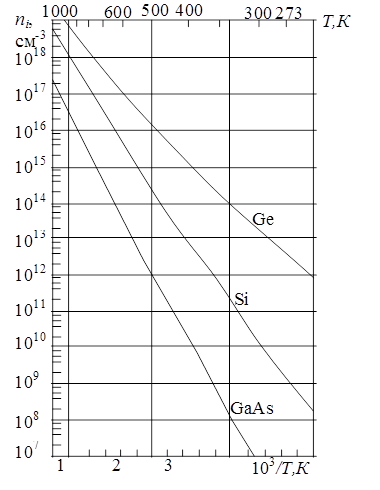
Рисунок 2.6 – Залежність власної концентрації носіїв заряду в германії, кремнії і арсеніді галію від температури
або розраховуємо за формулою:
ni2 (T) = BT3e-ΔE/kT
де ni = 1,4·1010 см-3.
Рухливість електронів і дірок як функції координати розраховувалися за емпіричною формулою з використанням сумарної концентрації легуючої домішки N+(x).

де N+ – сумарна концентрація розсіювальних центрів. Інші параметри наведені в табл. 2.5.
Таблиця 2.5 – Параметри напівпровідників для визначення рухливості носіїв заряду
| Напівпровідник | μ1, см2/В.с | μ2, см2/В.с | N0, см-3 | a |
|---|---|---|---|---|
| Кремній | 65 | Для електронів 1265 | 8,5·1016 | 0,72 |
| 48 | Для дірок 447 | 6,3·1016 | 0,76 | |
| Германій | 50 | Для електронів 3850 | 8,1·1016 | 0,48 |
| 42 | Для дірок 1860 | 1,4·1016 | 0,43 |
Результати розрахунку наведені на рис. 2.7.
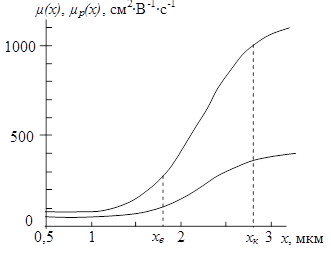
Рисунок 2.7 – Залежність рухливості електронів і дірок від координати в активній області структури транзистора
Середні значення рухливостей основних і неосновних носіїв заряду в шарах активної області структури визначалися як середні арифметичні значення від рухливостей на кордонах кожного шару і наведені в табл. 2.6. Наприклад, середні значення рухливостей електронів і дірок в активній базі визначалися як


Таблиця 2.6 – Електрофізичні та геометричні параметри р-n-переходів
| Параметр | Емітерний р-n-перехід | Колекторний р-n-перехід |
|---|---|---|
| Градієнт концентрації домішки а, см-4 | 1,23·1022 | 4,34·1020 |
| Контактна різниця потенціалів φк, В | 0,829 | 0,709 |
| Розширення ОПЗ в область бази при U = 0, лінійна апроксимація, см | 0,0875·10-4 | 0,253·10-4 |
| Ширина ОПЗ при U = 0, см | 0,175·10-4 | 0,507·10-4 |
| Глибина р-n переходу, см | 1,8·10-4 | 2,8 ·10-4 |
| Довжина l, см | 10·10-4 | 70·10-4 |
| Ширина z, см | 50·10-4 | 70·10-4 |
| Периметр П, см | 1,2·10-2 | 2,8·10-2 |
| Площа плоскої частини, см2 | 5·10-6 | 49·10-6 |
| Площа бічної частини, см2 | 3,39·10-6 | 12,3·10-6 |
| Повна площа А, см2 | 8,39·10-6 | 61,3·10-6 |
| Щільність зворотного струму насичення, А/см2 | 0,9·10-10 | 1,46·10-10 |
| Зворотний струм насичення, А | 0,756·10-15 | 8,95·10-15 |
| Бар'єрна ємність у режимі Ie= 1 мА, Uк = - 5 В, пФ | 0,990 | 0,556 |
Середнє значення коефіцієнта дифузії визначалося зі співвідношення Ейнштейна з використанням середньої рухливості неосновних носіїв заряду в кожному шарі. Середнє значення дифузійної довжини розраховувалося за формулою
 .
.
Середні значення концентрації основних носіїв заряду вважалися такими, що дорівнювали середнім значенням результуючої концентрації домішки в кожному шарі. Середнє значення концентрації основних носіїв заряду в емітері
 .
.
З урахуванням профілю дифузійного розподілу домішки в активній області структури транзистора інтегрування останнього виразу дозволяє записати
 .
.
Таблиця значень функції помилок (erf-функції) наведена в додатку В. Ці значення можна розрахувати і за допомогою наближеного виразу
 .
.
Середня концентрація домішки в активній і пасивній областях бази розрізняються (див. табл. 2.3). Середня концентрація домішки в пасивній області бази розраховується за формулою
 .
.
Середня концентрація домішки в активній області бази
 .
.
У цій формулі величина G називається числом Гуммеля і визначається виразом
 .
.
Вважаємо, що в колекторі середнє значення концентрації домішки дорівнює N0.
Середня питома провідність і питомий опір кожного шару розраховані за формулами
 ;
;  ,
,
де µОНЗ – середнє значення рухливості основних носіїв заряду в даному шарі.
Питомий поверхневий опір (опір шару) розраховувався як відношення середнього питомого опору до товщини шару. Наприклад, в активній базі
ρSБА = ρБА /ωбт = 0,558/10-4 = 5,58∙103 Ом/□ = 5,58 кОм/□,
у пасивній базі
ρSБП =ρБП /хк = 7,21 ∙ 10-2/2,8∙10-4 = 257 Ом/□.
Слід зазначити, що розрахунок питомого опору ρSБА за незалежно усередненими значеннями рухливості і концентрації основних носіїв заряду дає значення ρSБА з похибкою приблизно 20%, однак при оцінних розрахунках така помилка допустима. Результати розрахунку середніх значень електрофізичних параметрів транзистора зведені в табл. 2.3.
У транзисторі, отриманому методом дифузії домішки, розрахунок ширини ОПЗ емітерного і колекторного р-n-переходів є складною задачею і в загальному випадку потребує залучення числових методів. Проте в кожному конкретному випадку можна знайти вдалі апроксимації, які дозволяють оцінити ширину ОПЗ колекторного і емітерного р-n-переходів.
Розподіл домішки в активній області структури, побудований за даними табл. 2.4, наведено на рис. 2.8.

Рисунок 2.8 – Залежність концентрації легуючої домішки від координати в активній області структури транзистора
Для оцінювання ширини ОПЗ і контактної різниці потенціалів реальний розподіл домішки у районі координат хе і хк можна замінити лінійним (криві 1 і 2). Вираз для градієнта концентрації домішки отримаємо, диференціюючи дифузійний розподіл домішки в активній області за х:

Розраховані за цією формулою значення градієнтів концентрації домішки в емітерному ae = |a (xe)| і колекторному aк = |a (xк)| р-n-переходах наведені в табл. 2.6. Там же подані значення контактної різниці потенціалів емітерного і колекторного переходів, розраховані за формулою
 ,
,
де φт = 0,026 В;
q = 1,6 · 10-19 Кл.
і значення рівноважної ширини ОПЗ цих переходів, розраховані за формулою

у припущенні лінійної апроксимації розподілу домішки. Враховуючи, що на емітерний р-n-перехід в активному режимі подано пряму напругу і ширина ОПЗ цього переходу менша за рівноважну, апроксимація розподілу домішки лінійною залежністю дає невелику похибку при розрахунках.
Апроксимація розподілу домішки в колекторному р-n-переході лінійною залежністю (крива 2), як випливає з рис. 2.8, є більш грубим наближенням при розрахунках розширення ОПЗ.
Для уточненого розрахунку ширини ОПЗ колектора замінимо реальний розподіл домішки N1(x) деяким експоненціальним розподілом
 .
.
Будемо вважати, що апроксимуюча крива N*1(х) збігається з кривою N1(х) в точках з координатами хе і хк. Ця умова дозволяє визначити
 ,
, .
.
Розрахунок з використанням значень N1(хе) = -3,85·1017 см-3 і N1(хк) = 1,01·1016 см-3 за табл. 2.4 дозволяє визначити к*1 = 3,64·104 см-1; N10* = 2,7·1020 см-3. Таким чином, ми замінили реальний розподіл домішки N(х), визначений раніше, в районі колекторного переходу наближеним експоненціальним розподілом
 .
.
Цей розподіл домішок нанесено на рис. 2.8 штриховою лінією (крива 3) і досить близький до реального розподілу домішки.
Для р-n-переходу з експоненціальним розподілом домішки теорія дає таке трансцендентне рівняння, що пов'язує в неявному вигляді повну ширину ОПЗ р-n-переходу δ з прикладеною напругою U:
 . (2.1)
. (2.1)
При малих кδ < 2 функція F(кδ) ≈ (кδ)3 / 12. Якщо позначити праву частину рівняння через B = εε0κ2(φκ -U )/(qN0), то можна визначити
 . (2.2)
. (2.2)
Це розв’язання відповідає апроксимації експоненціального розподілу домішок поблизу точки х до лінійної залежності і дає похибку менше 5% при В < 0,6. При великих κδ > 4 cth (κδ /2) ≈ 1, і тому
F (κδ) ≈ (κδ)2 /2 - κδ = B. (2.3)
Розв’язання отриманого квадратного алгебраїчного рівняння щодо κδ дає
 . (2.4)
. (2.4)
При В > 100 величина  з похибкою не більше 7%, що відповідає апроксимації розподілу домішки в р-n-переході ступінчастою залежністю. У діапазоні 0,6 < В < 100 р-n-перехід є плавним і найкращі результати виходять при розрахунку значень κδ за допомогою модифікованого виразу
з похибкою не більше 7%, що відповідає апроксимації розподілу домішки в р-n-переході ступінчастою залежністю. У діапазоні 0,6 < В < 100 р-n-перехід є плавним і найкращі результати виходять при розрахунку значень κδ за допомогою модифікованого виразу
 . (2.5)
. (2.5)
Цей вираз при В > 0,6 дає похибку не більше 5%, Графік залежності F (κδ) відповідно до виразу для F (κδ) і апроксимації цієї залежності наведені на рис. 2.9.
Для колекторного р-n-переходу величина к, що входить в рівняння (2.1), дорівнює κ*1, а величина δ визначає ширину ОПЗ колектора δκ. За заданим значенням U можна за допомогою графіка, зображеного на рис. 2.9, або за формулами (2.2) – (2.5) визначити добуток κδκ, а потім знайти δκ.
Наприклад, для колекторного р-n-переходу при U = 0 права частина рівняння (2.1)


Рисунок 2.9 – Номограма для розрахунку розширення
ОПЗ-колектора р-n-переходу
З графіка рис. 2.9 знаходимо відповідне значення κ1*δκ = 2κ і розраховуємо δκ = 2/ κ1* = 2/ 3,64·104 = 0,539·10-4 см = 0,549 мкм. Це значення дещо більше від значення 0,507 мкм, отриманого при заміні розподілу домішки лінійним. Розширення ОПЗ колектора в область р-бази δ1κ і в область n-колектора δ2κ пов'язані з повною шириною ОПЗ співвідношеннями:
 ;
;
 .
.
Значення δ1κ δ2κ можна розрахувати за наведеними формулами або визначити з графіка (рис. 2.9): κ1*δ1κ = 0,84 ; κ2*δ2κ = 1,16, звідки δ1κ = 0,23 мкм; δ2κ = 0,32 мкм. Визначені за даною методикою значення δ1κ, δ2κ і δκ як функції зворотної напруги зміщення колекторного переходу наведено в табл. 2.7.
Таблиця 2.7 – Дані до розрахунку розширення ОПЗ колектора
| UК, B | B | κδκ | δκ, мкм | δ1κ, мкм | δ2κ, мкм |
|---|---|---|---|---|---|
| 0 -1 -2 -4 -5 -6 -8 -10 -20 -30 -40 -50 -60 | 0,62 1,50 2,38 4,14 5,02 5,90 7,66 9,42 18,2 27,0 35,8 44,6 53,4 | 2,02 2,81 3,25 3,95 4,25 4,50 5,04 5,46 7,12 8,42 9,52 10,5 11,4 | 0,549 0,769 0,892 1,08 1,17 1,24 1,38 1,50 1,95 2,31 2,61 2,88 3,13 | 0,230 0,302 0,335 0,385 0,393 0,412 0,450 0,467 0,539 0,585 0,619 0,646 0,668 | 0,320 0,467 0,558 0,701 0,755 0,810 0,334 1,03 1,42 1,73 1,99 2,24 2,46 |
Емітерний р-n-перехід складається з плоскої частини, розміри якої збігаються з розмірами вікна в плівці оксиду, створеного методом фотолітографії для дифузії емітерної домішки і бічних частин, пов'язаних з бічною дифузією домішки. Будемо вважати, що бічна поверхня р-n-переходу являє собою частину циліндричної поверхні з радіусом, що дорівнює глибині залягання р-n-переходу. Геометричні розміри р-n-переходів наведені в табл. 2.6.
Площа плоскої частини емітера
 см2.
см2.
Площа бічної частини емітера
 см2.
см2.
Повна площа емітера
 см2.
см2.
Аналогічно розраховується площа колекторного р-n-переходу. Результати розрахунку зведені в табл. 2.6.
3. Для проведення розрахунків коефіцієнтів передачі струму необхідно визначити ширину квазіелектронейтральної бази з урахуванням розширення ОПЗ р-n-переходів. Розширення ОПЗ колектора в базу при Uκ = -5 В (робочий режим) наведено в табл. 2.7 і складає δ1κ = 0,393 мкм. Розрахунок розширення ОПЗ емітера в базу δ2e ускладнений тією обставиною, що пряма напруга на емітері невідома. У робочому режимі в колі емітера заданий прямий струм ІЕ = 1 мА. Напругу на емітері можна обчислити за формулою
 .
.
Номінальна густина струму емітера
 А/см2.
А/см2.
Величина j'e0 поки невідома, але її можна оцінити, враховуючи, що зворотний струм емітера визначається в основному електронною складовою, яку можна розрахувати за відповідною формулою з урахуванням даних табл. 2.3:
 А/см2.
А/см2.
На відміну від даного в табл. 2.3, значення коефіцієнта дифузії усереднено в діапазоні х від 1,8 до 2,407 мкм. Остаточно за останньою формулою знаходимо Uе = 0,710 В, вважаючи j'eo ≈ j'ens.
Розширення ОПЗ емітера в область бази
 см = 4,5 · 10-2 мкм.
см = 4,5 · 10-2 мкм.
Методика розрахунку коефіцієнта переносу складається з двох етапів. На першому етапі за допомогою числового інтегрування знаходимо розподіл концентрації неосновних носіїв заряду в квазінейтральній базі в межах від х2е= 1,845 мкм до х1к = 2,407 мкм

Обчислення інтеграла показано в табл. 2.8.
Розділимо інтервал інтегрування на 10 частин. Інтегрування зручно вести за методом трапецій, обчислюючи значення інтеграла за формулою
 (2.6)
(2.6)
де Н - крок інтегрування, який в даному випадку дорівнює 0,0562 мкм;
у0 і уn - початкове і кінцеве значення функції.
Таблиця 2.8 – До розрахунку інтеграла (2.6)
| Номер кроку | х, мкм | N(x), см-3 | N+(x), см-3 | Dn(x), см2/с | N+(x)/Dn(x), см-5/с | Δn(x), см-3 |
|---|---|---|---|---|---|---|
| 0 1 2 3 4 5 6 7 8 9 10 | 2,4070 2,3508 2,2946 2,2384 2,1822 2,1260 2,0698 2,0136 1,9574 1,9012 1,845 | -3,654Е16 -4,589Е16 -5,55Е16 -6,727Е16 -7,841Е16 -8,872Е16 -9,670Е16 -10,016Е16 -9,598Е16 -7,975Е16 -4,556Е16 | 6,574Е16 8,048Е16 9,772Е16 1,227Е17 1,528Е17 1,914 Е17 2,408Е17 3,045Е17 3,869Е17 4,935Е17 6,315Е17 | 19,5 18,3 17,2 15,8 14,6 13,4 12,1 11,0 9,88 8,85 7,91 | 1,873Е15 2,505Е15 3,231Е15 4,244Е15 5,370Е15 6,642Е15 7,959Е15 9,U7E15 9,712Е15 9,008Е15 5,760Е15 | 0 1,675Е15 3,199Е15 4,592Е15 6,093Е15 7,762Е15 9,774Е15 1,243Е16 1,641Е16 2,338Е16 4,749Е16 |
Інтегрування можна вести за методом трапецій, але більшу точність дає метод парабол (метод Сімпсона), відповідно до якого
 .
.
На цій стадії можна уточнити значення струму jens.

За методом парабол обчислимо  см-5·с.
см-5·с.
Остаточно i>jens = 0,899·10-10 А/см2. В даному випадку метод трапецій дає помилку менше 3%. При розрахунку Δn(x) задавалося значення jnк = 103 А/см2.
На другому етапі за обчисленою залежністю Δn(x) знаходимо значення струму об'ємної рекомбінації електронів в базі на основі формули
 .
.
Обчислення за методом трапецій дає  см-2, а за методом парабол – 5,99·1011 см-2.
см-2, а за методом парабол – 5,99·1011 см-2.
Відповідно до даної формули
 А/см2.
А/см2.
Знайдемо коефіцієнт переносу для нормального режиму

 .
.
Якщо коефіцієнт інжекції дорівнював би одиниці, то коефіцієнт передачі струму бази дорівнював би  .
.
Обчислення коефіцієнта інжекції yN це складна задача, розв’язання якої в загальному випадку потребує застосування числових методів. У даному розрахунку розглянемо метод оцінення, що дозволяє оцінити yN. Почнемо з попереднього розрахунку струму дірок jер, інжектованих в квазіелектронейтральну область n+-емітера. Дірки, інжектовані в емітер, попадають в сильне гальмівне електричне поле, обумовлене нерівномірним розподілом донорів в емітері. Напруженість цього поля на лівій границі ОПЗ емітера при x = х1е = 1,8 – 0,045 = 1,755 мкм визначається виразом
 .
.
Значення N(x1е) = 7,63·1016 см-3 обчислюємо за формулою з визначення профілю дифузійного розподілу домішок. Значення при x = x1е обчислюємо за формулою для градієнта концентрації домішки: ае = -1,85·1022 см-4. Звідси, напруженість поля ε (x1е) = 6,25·103 В/см.
Таким чином, дірки в емітері дифундують проти електричного поля. Як відомо з фізики напівпровідників, в цьому випадку для опису розподілу дірок від координати слід користуватися не дифузійною довжиною, а довжиною затягування або дифузійною довжиною проти поля
 .
.
У цій формулі величина  називається фактором поля. Вважаючи, що μре = 100 см2·В-1·с-1 (див. рис. 2.7),
називається фактором поля. Вважаючи, що μре = 100 см2·В-1·с-1 (див. рис. 2.7),  см2·с-1; Lpе = 1,5 мкм обчислюємо ηе = 18,2; L* = 4,13·10-6 см = 4,13·10-2 мкм.
см2·с-1; Lpе = 1,5 мкм обчислюємо ηе = 18,2; L* = 4,13·10-6 см = 4,13·10-2 мкм.
Дірковий струм емітера на границі ОПЗ
 .
.
Передекспоненційний множник визначає густину діркового струму насичення емітера. Враховуючи, що  см-3, можна розрахувати
см-3, можна розрахувати
 А/см2.
А/см2.
При оцінюванні значення струму jеps вважалося, що дифузія дірок проти поля відбувається в постійному електричному полі напруженістю, яка дорівнює ε (х1е). Реально напруженість гальмівного електричного поля спадає практично лінійно до поверхні кристала. Тому в середньому вплив поля ε (х1е) слабкіший і значення струмів jеs та jеps дещо більше. Однак, зберігаючи отримані оцінні значення, знайдемо коефіцієнт інжекції за формулою
 .
.
Використовуючи отримане раніше значення jеns = 0,899·10-10 А/см2, отримуємо  і величину
і величину  .
.
Якби коефіцієнт ΧN дорівнював би одиниці, то коефіцієнт передачі струму бази дорівнював би  . З урахуванням раніше обчисленого значення ΧN величина
. З урахуванням раніше обчисленого значення ΧN величина  , а
, а  .
.
Таким чином, у даному випадку коефіцієнт передачі струму бази βN більшою мірою визначається значенням коефіцієнта переносу. При більшому, ніж в даному прикладі, часі життя електронів у базі коефіцієнт βN більшою мірою буде визначатися коефіцієнтом інжекції ϒN.
Складові щільності струму насичення емітерного р-n-переходу розраховані раніше. Повна густина струму насичення емітера
 А/см2.
А/см2.
З урахуванням повної площі емітера знайдемо струм насичення емітера
 А/см2.
А/см2.
Як і в транзисторі з однорідною базою, складова струму насичення колектора, обумовлена термогенерацією неосновних носіїв заряду (електронів) у базі,  А/см2.
А/см2.
Діркова складова струму насичення, обумовлена термогенерацією дірок в квазіелектронейтральному колекторі, визначається тією ж формулою, якщо в ній замінити індекс n на р і навпаки. Тоді густину струму jкрs можна розрахувати за формулою
 .
.
Вважаючи, що початкова ширина n-області колектора ωкт = 2,5 мкм (табл. 2.3) і в робочому режимі при Uк = - 5 В &delta2к = 0,755 мкм (табл. 2.7), отримуємо ширину квазіелектронейтральної області колектора:  мкм. Відповідно до даних табл. 2.3
мкм. Відповідно до даних табл. 2.3  . При цьому значенні аргументу відповідно до таблиці додатка В маємо th 0,594 ≈ 0,531.
. При цьому значенні аргументу відповідно до таблиці додатка В маємо th 0,594 ≈ 0,531.
На підставі цих даних отримуємо
 А/см2.
А/см2.
Густина струму насичення колектора
 А/см2.
А/см2.
Струм насичення колектора з урахуванням повної площі колектора (див. табл. 2.6).
 А/см2.
А/см2.
Опір активної області бази розрахуємо використовуючи дані табл. 2.3:
 ,
,  Ом.
Ом.
Опір пасивної області бази
 ,
,  Ом.
Ом.
Опір розтікання базового контакту розрахуємо за формулою
 .
.
Приймемо
ρс = 3,0·10-5 Ом·см2; ум = у3 – у2 = 10 мкм.
Аргумент гіперболічного котангенса
 ,
,
відповідно cth 2,93 ≈ 1 і опір
 Ом.
Ом.
контактний опір  Ом.
Ом.
Опір бази транзистора
rБ = rБА + rБП + rБМ ≈ 140 + 26 + 9 = 175 Ом.
Опір тіла колектора має дві складові, перша з яких визначається напругою на опорі високоомного шару колектора n-типу електропровідності, а друга – напругою на опорі низкоомної підкладки n+-типу з концентрацією домішки Nn = 1020 см-3, питомим опором ρn = 0,88·10-3 Ом·см і товщиною ωn = 200 мкм. Перша складова
 Ом.
Ом.
Товщина квазіелектронейтрального n-колектора розраховувалася при Uк = 0 з урахуванням даних табл. 2.7. При цьому δ2к = 0,32 мкм і ωк = ωкт - δ2к = 2,5 - 0,32 = 2,18 мкм.
Друга складова
rкк2 ≈ ρnωn/Ае = 0,88·10-3 · 200·10-4 / 5·10-6 ≈ 3,5 Ом.
Результуючий опір тіла колектора
rкк = rкк1 + rкк2 = 26 + 3,5 =29,5 Ом.
Розрахуємо питому бар'єрну ємність емітера при Uе = 0 (ширина ОПЗ дана в табл. 2.6)
 см2.
см2.
Бар'єрна ємність емітера при Uе = 0
 Ф = 0,509 пФ.
Ф = 0,509 пФ.
У робочому режимі при Іе = 1 мА маємо Uе = 0,71 В, δв = 0,09 мкм і бар'єрна ємність емітера Се бар = 0,9·10-12 Ф = 0,99 пФ.
Питому і повну бар'єрну ємність колектора розраховуємо при Uк = - 5 В (при цьому δк = 1,17 мкм, як випливає з табл. 2.7):
 Ф/см2;
Ф/см2;
Ск бар = Ак · С'к бар = 61,3·10-6·0,908·10-8 = 0,556·10-12 Ф = 0,556 пФ.
4. Розрахуємо параметри Т-подібної еквівалентної схеми для малого сигналу в робочій точці. Диференціальний опір емітера r при Iе = 1 мА становить 25,8 Ом
 .
.
Розрахуємо першу складову диференціальної вихідної провідності g'к в робочій точці Iе = 1 мА; Uк = - 5 В. Оскільки величина αN і ширина ОПЗ визначалися числовими методами, розрахунок g'к треба вести з використанням такої формули
 .
.
Проведений раніше розрахунок показав, що при Iе = 1 мА; Uк = - 5 В величина ΧN = 1 - 6,07·10-3; ϒN = 1 - 2.17·10-3; αN = 1 - 8,24·10-3; βN = 121,4 (така форма запису краща для збереження точності значення параметрів). За вже наведеною числовою методикою треба повторити всі розрахунки при зміні напруги на колекторі, наприклад, на 1 В. Задаючи Uк = - 6 В, отримуємо: ΧN = 1 - 5,88·10-3; ϒN = 1 - 2,15·10-3; αN = 1 - 8,03·10-3; βN = 124,5.
Остаточно отримуємо
 Ом-1.
Ом-1.
Якби ця складова була єдина, то диференціальний опір колектора бази дорівнював би rκ = 1/ g'κ = 4,76 МОм.
Для визначення другої складової провідності колектора g"κ необхідно розрахувати струм генерації носіїв в ОПЗ колектора, який визначається такою формулою:
 ;
;  ,
,
де τ0к = 7,26·10-8 с – генераційний час життя носіїв заряду в р-n переході.
Скориставшись даними табл. 2.7 при Uк = - 5 В, отримаємо δк = 1,17 мкм; IRGK = 1,106·10-10 А, а при Uк = - 6 В отримаємо δк = 1,24 мкм; IRGK = 1,172·10-10 А.
На підставі цих даних обчислюємо
 Ом-l.
Ом-l.
Таким чином, g'κ << g"κ, і тому диференціальний опір колектора rк = 4,76 МОм.
Розраховуємо коефіцієнт зворотного зв'язку за напругою. Відповідно до граничних умов для концентрації неосновних носіїв
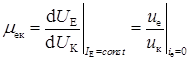 ;
; ,
,
Знайдемо з цього виразу напругу

Задамо напругу на колекторі Uк = - 5 В. При цьому з табл. 2.8 маємо Δne1 = Δn(x2e) = 4,749·1016 см-3 при хe = 1,845 мкм. Збільшимо зворотну напругу колектора на 1 В до Uк = 6 В. Проводячи обчислення Δn(х) за викладеною раніше методикою, отримуємо Δne1 = Δn(x2e) = 4,749·1016 см-3. Нехтуючи у формулі одиницею, знаходимо
 В.
В.
Оскільки зміна напруги ΔUк складає 1 В, то
 .
.
Опір бази та коефіцієнти передачі струму бази розраховані раніше.
5. Спочатку оцінимо напругу пробою колекторного переходу, аппроксимуючи розподіл домішок у ньому лінійним законом з градієнтом ак = 4,34·1020 см-4. Розрахунок за формулою
 ,
,
дає UК проб ≈ 52 В. Це груба оцінка. Номограми, основані на точних розрахунках напруги лавинного пробою, наведені в книзі І. В. Грехова, Ю. Н. Сережкина. «Лавинный пробой р-п перехода в полупроводниках» (Ленинград: Енергия, 1980, С. 62), З цими номограмами можна уточнити значення UК проб ≈ 65 В.
Напругу лавинного пробою емітерного р-п-переходу можна також оцінити за цією ж формулою. Оцінювання дає UЕ проб = 14 В.
Дані табл. 2.7 показують, що напруга змикання Uзм значно перевищує напругу лавинного пробою колектора.
Пробивну напругу колектора транзистора зі спільним емітером при нульовому струмі бази можна оцінити за формулою
 ,
,
вважаючи n = 3, βN0 = 121 [βN = αN / (1 - αN)] і UК проб = 65 В:
 В.
В.
Треба зазначити, що отримане значення годиться тільки як дуже груба оцінка.
Будемо вважати, що для кремнієвого транзистора максимальна температура переходу Тj max = 150 °C. Тепловий опір перехід – корпус, враховуючи малі розміри емітера і бічне розтікання тепла, можна оцінити за формулою
 К / Вт.
К / Вт.
Вибираємо корпус з тепловим опором Rтк-с = 300 К / Вт. Тоді повний тепловий опір Rтп-с = Rтп-к + Rтк-с = 454 °С/Вт. При температурі навколишнього середовища Т0 = 25 °С максимальна потужність, що розсіюється колектором,
 Вт.
Вт.



