2.7 Розробка проекту повного технологічного маршруту створення КМДН-структури
Технологічний маршрут виготовлення КМДН-структури являє собою послідовність технологічних операцій, необхідних для формування інтегральних п- і р-канальних транзисторів, області ізоляції та металізації.
Технологічні маршрути створення КМДН-структури можуть істотно відрізнятися один від одного залежно від конструктивно-технологічних параметрів МДН-транзисторів: довжини каналу, глибини залягання стоку-витоку, типу та кількості карманів, типу ізоляції. При цьому можна виділити дві групи маршрутів створення КМДН-структури, що мають спільні операції і відрізняються тільки типом ізоляції: LOCOS (локальний ізолювальний оксид кремнію) або STI (щілинна ізоляція).
У табл. 2.3 наведені спрощені повні маршрути створення КМДН-структури з різними типами ізоляції. Ескізні технологічні маршрутні схеми, що являють собою ілюстрації основних етапів технологічного маршруту, показані на рис. 2.2.
Таблиця 2.3 – Технологічні маршрути створення КМДН-структури з використанням ізоляцій LOCOS і STI

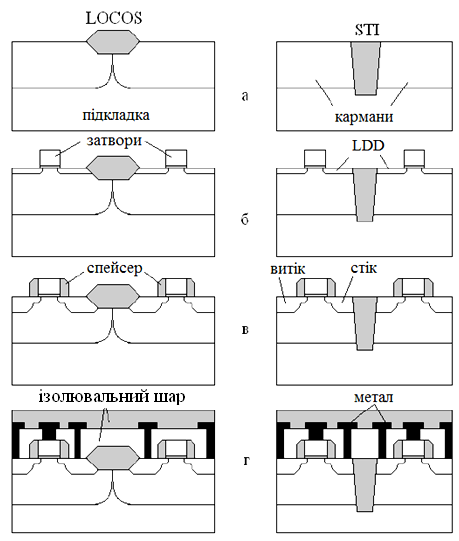
Рисунок 2.2 – Ескізні технологічні маршрутні схеми створення КМДН-структур з LOCOS (ліворуч) і щілинною (STІ) (праворуч) ізоляціями: а – вибір підкладки, створення ізоляції та карманів, б – коригування Uпор, створення затворів і LDD-областей; в – створення спейсерів та стоків-витоків; г – створення ізолювальних шарів і металізації
Наведені, як приклад, технологічні маршрути і маршрутні схеми є досить приблизними і загальними. На даному етапі виконання курсової роботи необхідно скласти більш докладний маршрут із зазначенням окремих технологічних операцій та їх режимів. Крім того, слід більш детально проілюструвати маршрут рисунками маршрутної карти, оскільки з вихідних даних вже відомо багато конструктивно-технологічних параметрів КМДН-структури (тип ізоляції, тип і кількість карманів, тип затвора, розміри, глибини і концентрації домішок у деяких областях).
Інші приклади маршрутів та режимів технологічних операцій (енергій і доз імплантацій, температур і часу відпалів, товщин нанесених і видалених шарів тощо) можна знайти в [7, 8].
Для прикладу індивідуального завдання наведемо КМДН-структуру, що містить такі елементи:
• п-канальний МДН-транзистор з р+-Si*-затвором на р-підкладці ;
• р-канальний МДН-транзистор з р+-Si*-затвором у п--кармані на р-підкладці;
• область щілинної ізоляції (STI) між транзисторами;
• металізацію.
Приклад повного технологічного маршруту створення КМДН-структури у відповідності з вихідними даними наведено нижче (виділено основні етапи виготовлення).
Вибір підкладки: р-тип, КДБ-10 (N = 1015 см-3), кристалографічна орієнтація поверхні (100).
1. Створення щілинної ізоляції (SТI) між транзисторами:
• фотолітографія «SТI»;
• анізотропне травлення Si на глибину залягання кармана (6–7 мкм) ;
• видалення фоторезиста;
• заповнення щілини з використанням SiO2.
2. Створення п-кармана:
• окислення: 1000 °С, 30 хв;
• фотолітографія «п-карман» ;
• імплантація: Р , Е = 80 кеВ, D = 5•1012 см-2;
• видалення фоторезиста;
• відпал (розгонка) карманів:
- дифузія: 1200 °С, 30 хв, окислювальне середовище – О2;
- дифузія: 1200 °С,90 хв, нейтральне середовище – N2;
• Видалення всього SiO2 до Si.
3. Коригування порогової напруги МДН-транзисторів:
• окислення: 1000 °С, 30 хв;
• фотолітографія «Коригування пороговї напруги п-МДН-транзистора»;
• імплантація: В, Е = 30 кеВ, D = 1•1012 см-2;
• видалення фоторезиста;
• фотолітографія «Коригування порогової напруги р-МДН-транзистора»;
• імплантація: Р, Е = 30 кеВ , D = 1•1012 см-2;
• видалення фоторезиста;
• видалення всього SiO2 до Si.
4. Створення підзатворного SiO2 товщиною 100 нм: 900 °С, 30 хв, середовище – О2.
5. Створення р+ - Si*-затворів :
• нанесення р+-полікремнію: товщина 1 мкм, елемент В, концентрація – 1•1020 см-3;
• фотолітографія «Затвори»;
• анізотропне травлення полікремнію на всю товщину до оксиду;
• видалення фоторезиста.
6. Створення п- і р-LDD-областей (LDD-області – це мілкі слаболеговані області, які подовжують області витоку і стоку в сторону каналу):
• фотолітографія «n – LDD»;
• імплантація: As, Е = 60 кеВ, D = 3•1013 см-2;
• видалення фоторезиста;
• фотолітографія «р-LDD»;
• імплантація: BF2 , Е = 50 кеВ , D = 5•1013 см-2;
• видалення фоторезиста.
7. Створення спейсерів: нанесення оксиду товщиною 0,5 мкм; анізотропне травлення оксиду на 0,5 мкм; окислення: 850 °С, 20 хв, О2.
8. Створення п - і р-витоків і стоків транзисторів:
• фотолітографія « п+ -стік, витік, контакт до п-кармана»;
• імплантація: As, Е = 60 кеВ, D = 5•1015 см-2;
• видалення фоторезиста;
• фотолітографія «р+-стік, витік, контакт до р-кармана (підкладки)»;
• імплантація: BF2 , Е = 50 кеВ , D = 4•1015 см-2;
• видалення фоторезиста;
• відпал: 900 °С, 30 хв, О2.
9. Осадження ізолювального шару і планаризація рельєфу поверхні.
10. Створення контактних вікон в ізолювальному шарі:
• фотолітографія «Контактні вікна»;
• анізотропне травлення оксиду до Si і Si*;
• видалення фоторезиста.
11. Створення металевого розведення:
• нанесення алюмінію;
• фотолітографія «Контакти»;
• анізотропне травлення алюмінію на всю його товщину;
• видалення фоторезиста.
12. Нанесення захисного ізолювального шару.
Розроблений технологічний маршрут необхідно подати у формі таблиці 2.4, в якій повинні бути вказані всі термічні операції, операції легування, осадження і травлення шарів, операції фотолітографії. Для кожної технологічної операції слід вказувати режими обробки або параметри одержуваних структур.
Таблиця 2.4 – Технологічна карта

Повна ескізна маршрутна схема складається як детальна ілюстрація розробленого технологічного маршруту виготовлення заданої КМДН-структури відповідно до індивідуального завдання і до елементів маршруту, наведених в [7, 8], а також в Додатку Д та Додатку Е.



