ЛАБОРАТОРНА РОБОТА № 3
КОНСТРУКТИВНИЙ РОЗРАХУНОК МДН-КОНДЕНСАТОРІВ
Мета роботи: визначити електрофізичні характеристики
МДН-конденсатора на основі SiO2, використовуючи
вихідні дані та характеристики матеріалу.
Теоретичні відомості
Конденсатори зі структурою МДН потребують виготовлення
тонкого окислу, такого ж, як і в МДН-транзисторів. Тому їх використання в ІС на
біполярних транзисторах недоцільно, оскільки це призводить до ускладнення технології виготовлення біполярних
ІС. Застосування МДН-конденсаторів
доцільно тільки в ІС на основі МДН-транзисторів [1 – 6].
Ідеальний МДН-конденсатор. На
рис. 3.1, а
показано спрощену структуру МДН-конденсатора. Як діелектрик в цих конденсаторах використовується двоокис кремнію. Верхня обкладинка конденсатора – метал, нижня
– напівпровідник
п- або р-типу.
Розглянемо
характеристики ідеального конденсатора, у якому не враховуються поверхневі стани на границі діелектрик ‒ напівпровідник, різниця робіт виходу структури
діелектрик ‒ метал ‒ напівпровідник
і заряд у діелектрику. Його
ємність
![]() , (3.1)
, (3.1)
де
![]() ‒ ємність, обумовлена діелектриком;
‒ ємність, обумовлена діелектриком;
![]() ‒ диференціальна
ємність напівпровідника.
‒ диференціальна
ємність напівпровідника.
Питома
ємність, обумовлена діелектриком:
 , (3.2)
, (3.2)
де
![]() – товщина діелектрика.
– товщина діелектрика.
Диференціальна
ємність ![]() залежить від величини
заряду в приповерхневому шарі
напівпровідника й довжини
шару.
залежить від величини
заряду в приповерхневому шарі
напівпровідника й довжини
шару.
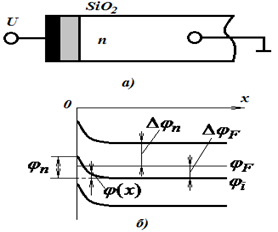
Рисунок 3.1 – Структура (а) і зонна діаграма (б) МДН-конденсатора
На рис. 3.1, б показана зонна діаграма границі діелектрик ‒ напівпровідник:
![]() ‒ поверхневий потенціал;
‒ поверхневий потенціал; ![]() ‒ функція потенціалу від
координати [
‒ функція потенціалу від
координати [![]() і
і ![]() ];
]; ![]() ‒ потенціал Фермі;
‒ потенціал Фермі; ![]() ‒ потенціал середини забороненої зони;
‒ потенціал середини забороненої зони; ![]() поза приповерхневого
шару. Будемо
вважати, що для напівпровідника п-типу
поза приповерхневого
шару. Будемо
вважати, що для напівпровідника п-типу ![]() й
й ![]() . Якщо
. Якщо ![]() збільшується, концентрація електронів у поверхневому шарі зменшується й утворюється область просторового
заряду товщиною [1 – 6]:
збільшується, концентрація електронів у поверхневому шарі зменшується й утворюється область просторового
заряду товщиною [1 – 6]:
При ![]() відбувається інверсія типу провідності, а при
відбувається інверсія типу провідності, а при ![]() ‒ сильне збагачення дірками.
‒ сильне збагачення дірками.
На
рис. 3.2 подано залежність ємності
![]() (3.1)
від зовнішньої напруги. Крива
(3.1)
від зовнішньої напруги. Крива ![]() відповідає статичному режиму.
відповідає статичному режиму.
Для
плоских зон ![]()
 ,
(3.4)
,
(3.4)
де  ‒ довжина
Дебая.
‒ довжина
Дебая.

Рисунок 3.2 – Залежність
відносної ємності МДН-конденсатора від
прикладеної напруги
При
![]() настає потужна інверсія й ширина шару просторового
заряду досягає максимального значення
настає потужна інверсія й ширина шару просторового
заряду досягає максимального значення
 . (3.5)
. (3.5)
Відповідна
![]() напруга
напруга
 , (3.6)
, (3.6)
де
![]() ‒ густина
позитивного заряду в приповерхневому шарі;
‒ густина
позитивного заряду в приповерхневому шарі;
![]() ‒ відповідна густина
просторового заряду дірок.
‒ відповідна густина
просторового заряду дірок.
У
виразі (3.6) передбачалось,
що ![]() . Подальше
збільшення
. Подальше
збільшення ![]() викликає появу просторового заряду дірок, який екранує внутрішній
шар просторового заряду, що
викликає зростання ємності
викликає появу просторового заряду дірок, який екранує внутрішній
шар просторового заряду, що
викликає зростання ємності ![]() . При робочих частотах
. При робочих частотах
![]() Гц просторовий заряд дірок не встигає відслідковувати зміну напруги і ємність
Гц просторовий заряд дірок не встигає відслідковувати зміну напруги і ємність ![]() не зростає (рис.
3.2, крива б,
не зростає (рис.
3.2, крива б, ![]() ) [1 – 6].
) [1 – 6].
В діапазоні зміни ![]()
 .
(3.7)
.
(3.7)
Як випливає із (3.1),
 .
(3.8)
.
(3.8)
Величина ![]() ( див. рис. 3.1, б) обчислюється зі співвідношення:
( див. рис. 3.1, б) обчислюється зі співвідношення:
![]() ,
,
де ![]() – різниця потенціалів між дном зони
провідності напівпровідника та рівнем Фермі
– різниця потенціалів між дном зони
провідності напівпровідника та рівнем Фермі ![]() ;
;
![]() –
ширина забороненої зони,
–
ширина забороненої зони,
а
 . (3.9)
. (3.9)
Реальний МДН-конденсатор. На
рис. 3.3 показано структуру МДН-конденсатора, використовувану
в ІС (![]() ‒ товщина плівки діелектрика).
‒ товщина плівки діелектрика).
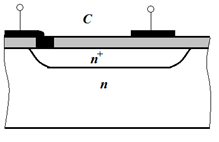
Рисунок 3.3 – Структура інтегрального МДН-конденсатора
Відмінність
її від структури
на рис. 3.1 полягає в тому, що для зменшення послідовного опору нижньої обкладинки конденсатора використовується
n+-шар.
Наявність останнього також зменшує залежність
ємності від зовнішньої напруги [1 – 6].
Аналіз
поверхневих станів на границі поділу Si-SiО2 показує, що їх врахування еквівалентно
уведенню в (3.6) деякого заряду ![]() поверхневих
станів, причому незалежно від кристалографічної орієнтації
поверхневих
станів, причому незалежно від кристалографічної орієнтації ![]() . У
табл. 3.1 подано значення
густини заряду
. У
табл. 3.1 подано значення
густини заряду ![]() для різних
кристалографічних площин.
для різних
кристалографічних площин.
Таблиця 3.1 – Густина заряду
поверхневих станів
|
Кристалографічна площина |
|
|
|
|
|
5,0 |
2,0 |
0,9 |
Різниця робіт виходу структури
метал ‒ діелектрик ‒ напівпровідник
![]() , (3.10)
, (3.10)
де ![]() й
й ![]() – робота виходу
металу й висота потенційного бар'єра на границі напівпровідник ‒ діелектрик.
– робота виходу
металу й висота потенційного бар'єра на границі напівпровідник ‒ діелектрик.
Для границі поділу Si-SiО2
![]() В при
В при ![]() К. Значення
К. Значення ![]() для різних
металів наведено в табл. 3.2. Урахуємо також просторовий заряд, зазвичай
присутній у діелектрику (
для різних
металів наведено в табл. 3.2. Урахуємо також просторовий заряд, зазвичай
присутній у діелектрику (![]() ) [1 – 6].
) [1 – 6].
Таблиця 3.2
– Робота виходу металів
|
Метал |
Mg |
Al |
Ni |
Cu |
Ag |
Pt |
Au |
|
|
3,7 |
4,3 |
4,5 |
4,4 |
4,3 |
5,3 |
4,8 |
Розглянуті три фактори
впливають на величину ![]() .
З їхнім врахуванням з (3.6)
.
З їхнім врахуванням з (3.6)
![]() ,
(3.11, а)
,
(3.11, а)
де ![]() ‒ гранична
напруга транзистора.
‒ гранична
напруга транзистора.
Як правило, ![]() і його
значення визначається якістю технологічного процесу виготовлення ІС. Воно може
змінюватися в досить широких межах, погіршуючи стабільність
і його
значення визначається якістю технологічного процесу виготовлення ІС. Воно може
змінюватися в досить широких межах, погіршуючи стабільність ![]() .
Для забезпечення сталості
.
Для забезпечення сталості ![]() необхідно, щоб
необхідно, щоб ![]() . Спеціальні методи стабілізації
. Спеціальні методи стабілізації ![]() дозволяють
забезпечити
дозволяють
забезпечити ![]() Кл/см2, що знижує його вплив [
Кл/см2, що знижує його вплив [![]() Кл/см2](див. табл. 3.1). Тому при оцінних розрахунках
Кл/см2](див. табл. 3.1). Тому при оцінних розрахунках ![]() можна не враховувати й використовувати
співвідношення
можна не враховувати й використовувати
співвідношення
![]() . (3.11,б)
. (3.11,б)
У табл. 3.3 показано знаки
величин, що входять у співвідношення (3.11, б). Відповідно до виразу (3.11, б)
наявність ![]() і
і ![]() викликає
зрушення вольт-фарадної характеристики
МДН-конденсатора по осі напруг.
викликає
зрушення вольт-фарадної характеристики
МДН-конденсатора по осі напруг.
Таблиця 3.3 – Знаки величин, що входять у
співвідношення (3.11,б)
|
Тип провідності напівпровідника |
Знаки величин |
|||
|
|
|
|
|
|
|
n |
+ |
+ |
‒ |
‒ |
|
p |
+ |
‒ |
+ |
‒ |
У деяких випадках використовується діелектрик
більш складної структури: нітрид кремнію (Si3N4) ‒ двоокис
кремнію ‒ кремній. У цьому випадку для використання формули (3.2)
необхідно замінити ![]() на ефективне
значення
на ефективне
значення
 , (3.12)
, (3.12)
де![]() ,
, ![]() і
і![]() ,
, ![]() ‒ діелектричні проникності й товщини SiО2
і Si3N4, відповідно:
‒ діелектричні проникності й товщини SiО2
і Si3N4, відповідно:
![]() .
.
Напруга пробою
МДН-конденсатора визначається електричною міцністю SiО2, значення
критичної напруженості електричного поля ![]() В/см. Похибки виготовлення МДН-конденсатора при
В/см. Похибки виготовлення МДН-конденсатора при ![]() визначається
технологічними допусками на товщину діелектрика:
визначається
технологічними допусками на товщину діелектрика:
 .
(3.13)
.
(3.13)
Зазвичай похибка близько 20%. Температурна характеристика
МДН-конденсатора визначається температурною залежністю ![]() .
.
Завдання
Обчислити питому ємність ![]() , відношення
, відношення ![]() , граничну напругу
, граничну напругу ![]() , напругу пробою
, напругу пробою ![]() МДН-конденсатора
зі структурою, що подана на
рис. 3.3. Діелектрик SiO2 товщиною
МДН-конденсатора
зі структурою, що подана на
рис. 3.3. Діелектрик SiO2 товщиною ![]() см і діелектричною
проникністю
см і діелектричною
проникністю ![]() . Поверхневу концентрацію донорної домішки
. Поверхневу концентрацію донорної домішки ![]() візьмемо близько 1019
см-3. Крім того,
візьмемо близько 1019
см-3. Крім того, ![]() . Варіанти матеріалу контактної площадки,
тип провідності напівпровідника
та кристалографічна орієнтація
підкладки подані в таблиці 3.4.
. Варіанти матеріалу контактної площадки,
тип провідності напівпровідника
та кристалографічна орієнтація
підкладки подані в таблиці 3.4.
Таблиця
3.4 – Варіанти завдань
|
№
варіанта |
Матеріал контактної площадки |
Тип
провідності напівпровідника |
Кристалографічна орієнтація підкладки |
|
1 |
Mg |
n |
|
|
2 |
Al |
p |
|
|
3 |
Ni |
n |
|
|
4 |
Cu |
p |
|
|
5 |
Ag |
n |
|
|
6 |
Pt |
p |
|
|
7 |
Au |
n |
|
|
8 |
Mg |
p |
|
|
9 |
Al |
n |
|
|
10 |
Ni |
p |
|
|
11 |
Cu |
n |
|
|
12 |
Ag |
p |
|
|
13 |
Pt |
n |
|
|
14 |
Au |
p |
|
|
15 |
Al |
n |
|
|
16 |
Ni |
p |
|
|
17 |
Cu |
n |
|
|
18 |
Ag |
p |
|
|
19 |
Pt |
n |
|
|
20 |
Au |
p |
|
Звіт повинен містити
1.
Вихідні дані.
2. Конструктивний
розрахунок МДН-конденсатора.
3.
Креслення конденсатора.
4.
Лістинг програми.
5.
Результати тестування.
6. Висновки.
Контрольні
запитання
1.
Наведіть технологію виготовлення інтегрального МДН-конденсатора.
2. Охарактеризуйте структуру ідеального
МДН-конденсатора та наведіть його
характеристики.
3. Охарактеризуйте структуру реального МДН-конденсатора та наведіть його характеристики.
4.
Які фактори впливають на значення ємності МДН-конденсатора
?
