
6.7 Імпульсні і високочастотні властивості р-п-переходу
Імпульсні властивості. Іншою вельми широкою областю застосування напівпровідникових діодів є імпульсні схеми радіоелектроніки, обчислювальної техніки і автоматики. Основним параметром, що визначає придатність діодів для цієї мети, є їх швидкодія, що характеризується тривалістю перемикання р-n-переходу з прямого зсуву на зворотний і, навпаки, із зворотного на прямий.
Розглянемо якими процесами, що протікають в р-n-переході, визначається цей параметр. На рис. 6.14, а схемно показано розподіл основних і неосновних носіїв в р- і n-областях напівпровідника при рівноважному стані р-n-переходу. При поданні на діод прямого зсуву V потенціальний бар'єр переходу знижується на величину ![]() і потік основних носіїв через р-n-перехід збільшується в
і потік основних носіїв через р-n-перехід збільшується в ![]() раз, унаслідок чого концентрації дірок біля межі 2 n-області і електрони біля межі 1 р-області (див. рис. 6.14, б) зростають до
раз, унаслідок чого концентрації дірок біля межі 2 n-області і електрони біля межі 1 р-області (див. рис. 6.14, б) зростають до
![]() .
.
Дірки, що перейшли в n-область, і електрони, що перейшли в р-область, стають в цих областях неосновними носіями.
Таким чином, під дією прямого зсуву відбувається ніби «вприскування» неосновних носіїв через межі р-n переходу у відповідні області напівпровідника. Це явище одержало назву інжекції неосновних носіїв.
Дірки, інжектовані в n-область, притягують до себе електрони з об'єму цієї області, внаслідок чого концентрація електронів поблизу р-n-переходу підвищується в порівнянні з концентрацією в об'ємі (рис. 6.14, б). Негативний заряд притягуючих електронів екранує позитивний заряд надмірних дірок.
Така ж картина спостерігається і в р-області: позитивний заряд притягуючих дірок екранує негативний заряд інжектованих електронів. Тому надмірні дірки і електрони, інжектовані відповідно в n- і в р-області, не створюють в них об'ємних зарядів, які своїм полем могли б перешкоджати руху неосновних носіїв в об'єм напівпровідника, що не компенсується. Переміщення цих носіїв в глиб напівпровідника здійснюється виключно шляхом дифузії, швидкість якої пропорційна градієнту концентрації дірок ![]() у n-області і градієнту концентрації електронів
у n-області і градієнту концентрації електронів ![]() у р-області.
у р-області.
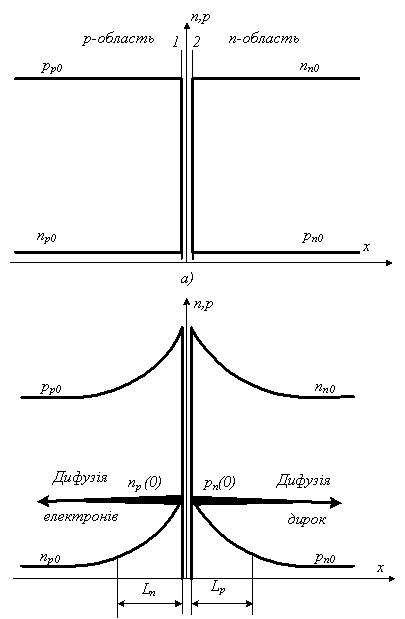
Рисунок 6.14 – Інжекція неосновних носіїв заряду
Таким чином, при перемиканні діода в ньому протікають перехідні процеси (накопичення неосновних носіїв при прямому зсуві і розсмоктування їх при зворотному зсуві), які і обмежують його швидкодію. Оскільки ці процеси завершуються в основному житті надмірних неосновних носіїв ![]() той цей час і визначає швидкодію імпульсних діодів.
той цей час і визначає швидкодію імпульсних діодів.
З розглянутої картини виходить, що відносно перемикання діод поводиться як опір ![]() , створений областю об'ємного заряду, і зашунтований ємністю СД, обумовленою накопиченням заряду неосновних носіїв при прямому зсуві і розсмоктуванням його при зворотному зсуві. Цю ємність називають дифузійною ємністю р-n-переходу. При поданні прямого зсуву струм в діоді в початковий момент є в основному струмом заряду ємності СД і за своєю величиною може бути великим. При перемиканні діода в зворотний напрям зворотний струм є в початковий момент в основному струмом розряду ємності Сд і також може бути великим.
, створений областю об'ємного заряду, і зашунтований ємністю СД, обумовленою накопиченням заряду неосновних носіїв при прямому зсуві і розсмоктуванням його при зворотному зсуві. Цю ємність називають дифузійною ємністю р-n-переходу. При поданні прямого зсуву струм в діоді в початковий момент є в основному струмом заряду ємності СД і за своєю величиною може бути великим. При перемиканні діода в зворотний напрям зворотний струм є в початковий момент в основному струмом розряду ємності Сд і також може бути великим.
Як показує розрахунок, для малого змінного сигналу
![]() (6.29)
(6.29)
де, як випливає з (6.26), ![]() і
і ![]() (V – постійний зсув на р-n-переході). Оскільки вже при незначних зворотних зсувах експонента
(V – постійний зсув на р-n-переході). Оскільки вже при незначних зворотних зсувах експонента ![]()
![]() 0, то і СД=0. При прямих зсувах jp
0, то і СД=0. При прямих зсувах jp ![]() jps і jn
jps і jn ![]() jns тому
jns тому
CД![]()
 (6.30)
(6.30)
Для дуже несиметричного р-n-переходу з Na![]() Nd(pp0
Nd(pp0![]() nn0) сумарні струми j і js, які протікають через перехід, практично рівні jp і jps, відповідно і
nn0) сумарні струми j і js, які протікають через перехід, практично рівні jp і jps, відповідно і
CД =
![]()

![]()
 (6.31)
(6.31)
З (6.29) – (6.31) витікає, що для зменшення СД і підвищення швидкодії діодів необхідно зменшувати час життя надмірних неосновних носіїв t, легуючи n- і р-області домішкою, що створює ефективні рекомбінаційні центри. Такою домішкою є, зокрема, золото, легування яким дозволяє знизити ![]() до декількох наносекунд.
до декількох наносекунд.
Частотні властивості р-n-переходу. Крім дифузійної ємності, електронно-дірковий перехід має ще так звану бар'єрну або зарядну ємність, пов'язану із зміною величини об'ємного заряду р-n-переходу під впливом зовнішнього зсуву.
Підвищення потеаціального бар'єра р-n-переходу при зворотному зсуві відбувається за рахунок розширення шару об'ємного заряду (рис. 6.11, д).
Прямий зсув викликає приток основних носіїв до області об'ємного заряду (рис. 6.11, г), в результаті якого заряди, створені зовнішнім джерелом ЕРС на омічних контактах, переносяться до р-n-переходу і звужують його (на рис. 6.11, г звуження р-n-переходу показано штриховкою).
Після встановлення стаціонарного стану практично вся напруга V спадає на р-n-переході, оскільки його опір на багато порядків вищий, ніж опір решти областей напівпровідника.
Таким чином, прикладена до р-n-переходу зовнішня напруга викликає появу в перший момент часу імпульсу струму в зовнішньому колі, що приводить кінець кінцем до збільшення або зменшення об'ємного заряду
р-n-переходу. Тому перехід поводиться як ємність. Її називають бар'єрною, або зарядною ємністю, оскільки вона пов'язана із зміною потенціального бар'єра р-n-переходу. При поданні на перехід зворотного зсуву бар'єрна ємність заряджається, при подачі прямого зсуву – розряджається.
З рис. 6.11, г, д видно, що плоский р-n-перехід подібний плоскому конденсатору. Тому величину бар'єрної ємності можна обчислювати за формулою плоского конденсатора
![]() (6.32)
(6.32)
де ![]() – площа р-n-переходу;
– площа р-n-переходу; ![]() – діелектрична проникність напівпровідника;
– діелектрична проникність напівпровідника; ![]() – товщина шару об'ємного заряду, що відіграє роль відстані між обкладками конденсатора. Відмінність від конденсатора полягає в тому, що
– товщина шару об'ємного заряду, що відіграє роль відстані між обкладками конденсатора. Відмінність від конденсатора полягає в тому, що ![]() у виразі (6.32) не є величиною постійною, а залежить від зовнішнього зсуву
у виразі (6.32) не є величиною постійною, а залежить від зовнішнього зсуву ![]() .
.
Для плавних р-n-переходів
Сб = S (6.33)
(6.33)
Цими формулами зручно користуватися для малого змінного сигналу, накладеного на постійний зсув V.
Таким чином, діод може бути поданий такою спрощеною еквівалентною схемою: паралельно нелінійному активному опору р-n-переходу ![]() приєднані нелінійна дифузійна Сд і бар'єрна С
приєднані нелінійна дифузійна Сд і бар'єрна С![]() ємності, послідовно з цим колом приєднаний опір
ємності, послідовно з цим колом приєднаний опір ![]() пасивних областей діода
пасивних областей діода
(рис. 6.15). Для з'ясування особливостей роботи діода на високих частотах проаналізуємо детальніше цю схему.
Активний опір р-n-переходу при малому змінному сигналі низької частоти визначається співвідношенням (6.28). При цьому під низькою частотою розуміється така частота сигналу ![]() , для якої період коливань набагато більший часу життя інжектованих носіїв, тобто
, для якої період коливань набагато більший часу життя інжектованих носіїв, тобто ![]()
![]() tp. У цьому випадку за час
tp. У цьому випадку за час ![]() у переході встигають протікати всі перехідні процеси і дифузійна ємність описується співвідношенням (6.31), а бар'єрна – (6.33).
у переході встигають протікати всі перехідні процеси і дифузійна ємність описується співвідношенням (6.31), а бар'єрна – (6.33).
У міру підвищення частоти сигналу ![]() часу
часу ![]() виявляється більшою мірою недостатньо для завершення перехідних процесів. Це повинно призводити до зменшення числа носіїв, інспектованих в позитивний півперіод сигналу, і тим самим до зменшення дифузійної ємності. Крім того, інжектовані носії не встигають продифундувати в глибину пасивних областей діода на дифузійну довжину, зосереджуючись з великим градієнтом в тонкому шарі біля меж р-n-переходу, що повинно призводити до збільшення прямого струму, тобто до зменшення активного опору р-n-переходу.
виявляється більшою мірою недостатньо для завершення перехідних процесів. Це повинно призводити до зменшення числа носіїв, інспектованих в позитивний півперіод сигналу, і тим самим до зменшення дифузійної ємності. Крім того, інжектовані носії не встигають продифундувати в глибину пасивних областей діода на дифузійну довжину, зосереджуючись з великим градієнтом в тонкому шарі біля меж р-n-переходу, що повинно призводити до збільшення прямого струму, тобто до зменшення активного опору р-n-переходу.
У негативний півперіод сигналу висока концентрація неосновних носіїв, що не встигли продефундувавти в глибину пасивних областей і локалізованих в тонкому шарі біля меж р-n-переходу, повинна також приводити до збільшення зворотного струму, а отже, до зменшення активного опору зворотно зміщеного переходу.
Таким чином, підвищення частоти сигналу, що подається на р-n-перехід, повинно приводити до зменшення активного опору ![]() а і дифузійної ємності СД. Як показує розрахунок для несиметричного р-n-переходу
а і дифузійної ємності СД. Як показує розрахунок для несиметричного р-n-переходу
 , (6.34)
, (6.34)
 . (6.35)
. (6.35)
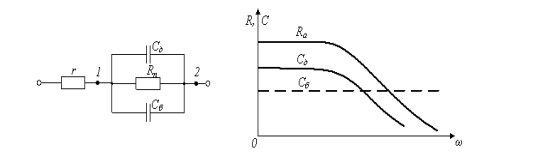
|
Рисунок 6.15 – Еквівалентна схема діода |
Рисунок 6.16 – Залежність актив-ного опору, дифузійної і бар’єрної ємності р-n-переходу від частоти |
Для низьких частот (![]() 1/
1/![]() ) ці вирази переходять в (6.28 і (6.31). Для високих частот (
) ці вирази переходять в (6.28 і (6.31). Для високих частот (![]() 1/
1/![]() ) одиницями в підкореневих виразах (6.34) і (6.35) можна нехтувати в порівнянні з
) одиницями в підкореневих виразах (6.34) і (6.35) можна нехтувати в порівнянні з ![]() . Тоді
. Тоді
![]()
 , (6.36)
, (6.36)
![]()
 . (6.37)
. (6.37)
Провідності, властиві опору![]() і ємності
і ємності ![]() рівні
рівні
![]() =
=![]()
![]() , (6.38)
, (6.38)
![]() =
= ![]()
![]() (6.39)
(6.39)
Як бачимо, вони рівні між собою: ![]() =
= ![]() .
.
Оскільки ![]()
![]() , а
, а ![]()
![]()
![]()
 =
= ![]() ,
,
то активний опір р-n-переходу на високих частотах не залежить від часу життя інжектованих носіїв і зменшується обернено пропорційно ![]() :
:
![]()
![]() . (6.40)
. (6.40)
Аналогічно поводиться і опір дифузійної ємності СД:
![]()
![]()
![]() (6.41)
(6.41)
На рис. 6.16 схематично подана залежність ![]() а і СД від частоти сигналу, штриховою прямою показана бар'єрна ємність р-n-переходу, не залежна від
а і СД від частоти сигналу, штриховою прямою показана бар'єрна ємність р-n-переходу, не залежна від ![]() . З рис. 6.16 видно, що на високих частотах бар'єрна ємність стає більше дифузійною, унаслідок чого її провідність
. З рис. 6.16 видно, що на високих частотах бар'єрна ємність стає більше дифузійною, унаслідок чого її провідність ![]() перевищує провідність дифузійної ємності і рівну їй активну провідність р-n-переходу.
перевищує провідність дифузійної ємності і рівну їй активну провідність р-n-переходу.
Зменшення на високих частотах опору р-n-переходу призводить до того, що велика частина напруги, прикладеної до діода, спадає не на переході, а на опорі пасивних областей діода. На частотах, на яких опір
р-n-переходу стає набагато меншим ![]() , струм як при прямому, так і при зворотному зсувах визначається вже не ним, а
, струм як при прямому, так і при зворотному зсувах визначається вже не ним, а ![]() , внаслідок чого діод втрачає свої властивості, що детектують. За максимальну частоту роботи діода (
, внаслідок чого діод втрачає свої властивості, що детектують. За максимальну частоту роботи діода (![]() ) приймають частоту, при якій величина еквівалентного опору р-n-переходу (між точками 1 і 2 рис. 6.15) виявляється рівною опору пасивних областей
) приймають частоту, при якій величина еквівалентного опору р-n-переходу (між точками 1 і 2 рис. 6.15) виявляється рівною опору пасивних областей ![]() . Оскільки на високих частотах еквівалентний опір
. Оскільки на високих частотах еквівалентний опір
р-n-переходу визначається бар'єрною ємністю ![]() , то при визначенні граничної частоти
, то при визначенні граничної частоти ![]() необхідно порівнювати
необхідно порівнювати ![]() з опором бар'єрної ємності Сб і оцінювати
з опором бар'єрної ємності Сб і оцінювати ![]() із співвідношення
із співвідношення
![]()
![]() . (6.42)
. (6.42)
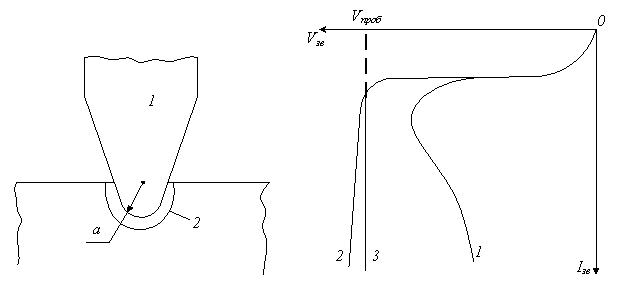
Рисунок 6.17 – Схема точкового діода |
Рисунок 6.18 – Пробій p-n-переходу: 1- тепловий; 2- тунельний; 3- лавинний |
З (6.42) витікає, що для збільшення граничної частоти роботи діода необхідно зменшувати ![]() . Опір
. Опір ![]() можна зменшувати, покращуючи якість омічних контактів до n- і р-областей діода і зменшуючи товщину цих областей. Здавалося б, що підвищити
можна зменшувати, покращуючи якість омічних контактів до n- і р-областей діода і зменшуючи товщину цих областей. Здавалося б, що підвищити ![]() можна також зменшенням площі
можна також зменшенням площі ![]() р-n-переходу, оскільки при цьому повинна зменшуватися ємність
р-n-переходу, оскільки при цьому повинна зменшуватися ємність ![]() . Проте у такий спосіб можна досягти підвищення
. Проте у такий спосіб можна досягти підвищення ![]() тільки у точкових діодів. Насправді для плоских переходів
тільки у точкових діодів. Насправді для плоских переходів ![]()
![]() , тому
, тому ![]() не залежить від S. Для точкових же діодів
не залежить від S. Для точкових же діодів ![]()
![]() =
=![]() , де
, де ![]() – питомий опір напівпровідника; а – радіус півсферичного контакту;
– питомий опір напівпровідника; а – радіус півсферичного контакту; ![]() – площа переходу (рис. 6.17). Оскільки
– площа переходу (рис. 6.17). Оскільки ![]() то
то ![]() і
і ![]()
![]() . Тому зменшенням
. Тому зменшенням ![]() можна досягти підвищення
можна досягти підвищення ![]() .
.
До збільшення ![]() приводить і зменшення питомого опору r – пасивних областей діода. Дійсно, наприклад, для несиметричного р-n-переходу з високоомною n-областю
приводить і зменшення питомого опору r – пасивних областей діода. Дійсно, наприклад, для несиметричного р-n-переходу з високоомною n-областю ![]() тому
тому ![]() де
де ![]() – питомий опір n-області. Слід, проте, пам'ятати, що із збільшенням ступеня легування пробивна напруга
– питомий опір n-області. Слід, проте, пам'ятати, що із збільшенням ступеня легування пробивна напруга
р-n-переходу cпадає і врешті-решт ми одержуємо спочатку характеристику оберненого діода (найбільш високочастотного), а при ще
сильнішому легуванні – тунельного діода, вже непридатного для детектування.