
9.7 Виготовлення елементів біполярних ІМС
Транзистори в інтегральних мікросхемах. В ІМС застосування транзисторів більш переважне, ніж пасивних елементів, внаслідок меншої площі, займаної ними. Транзистори у складі інтегральної мікросхеми дешевші дискретних, тому можна використовувати 5 – 10 транзисторів замість 2 – 3 в тому ж каскаді на дискретних приладах. Транзистори n-р-n-типу мають кращі характеристики і параметри, ніж р-n-р-транзистори, тому знайшли переважне застосування в ІМС. Технологія їх виготовлення більш економічна.
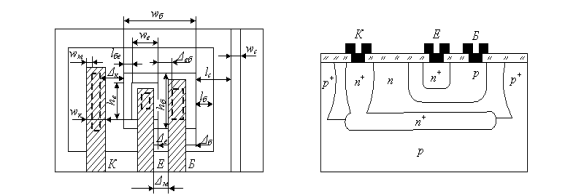
Рисунок 9.5 – Односмуговий звичайний транзистор – елемент ІМС |
Рисунок 9.6 – Структура планарного транзистора ІМС |
Розрізняють три різновиди структур транзисторів для інтегральних мікросхем: звичайна планарна, горизонтальна (латеральна) і з вертикальними переходами. В звичайній планарній структурі інтегрального транзистора (рис. 9.6), топологія якого була показана на рис. 9.5, емітерний і колекторний переходи, за винятком їх меж, розташовані паралельно поверхні пластини. На відміну від дискретних приладів, в яких колекторний контакт розміщений на протилежному боці пластини і служить місцем приєднання транзистора до кристалоутримувача, в інтегральних транзисторах всі контакти виведені на планарну сторону. Для мікропотужних схем більш придатна односмугова конфігурація виводів, показана на рис. 9.5, забезпечуюча мінімальну площу, займану транзистором. В схемі малої і високої потужності планарне розташування контактів веде до збільшення опору колектора і знижує швидкодію. Прихований сильнолегований шар з електропровідністю ![]() типу, одержуваний дифузією миш'яку або сурми в р-підложку перед вирощуванням епітаксійного шару n-типу, має низький опір і шунтує високоомну частину колекторної області. Введення прихованого шару дозволяє понизити опір колектора. Для додаткового зменшення опору колектора використовують транзистори з П-подібним розташуванням контакту (рис. 9.7). Для підвищення коефіцієнта передачі струму використовують двохемітерну конструкцію транзисторів (рис. 9.8). В логічних ІМС широко використовують багатоемітерні транзистори, що включають по чотири (і більше) окремі емітерні області, об'єднані загальним контактом. Активні області баз, розташовані під емітерними переходами, з’єднані одна з одною областю пасивної бази.
типу, одержуваний дифузією миш'яку або сурми в р-підложку перед вирощуванням епітаксійного шару n-типу, має низький опір і шунтує високоомну частину колекторної області. Введення прихованого шару дозволяє понизити опір колектора. Для додаткового зменшення опору колектора використовують транзистори з П-подібним розташуванням контакту (рис. 9.7). Для підвищення коефіцієнта передачі струму використовують двохемітерну конструкцію транзисторів (рис. 9.8). В логічних ІМС широко використовують багатоемітерні транзистори, що включають по чотири (і більше) окремі емітерні області, об'єднані загальним контактом. Активні області баз, розташовані під емітерними переходами, з’єднані одна з одною областю пасивної бази.
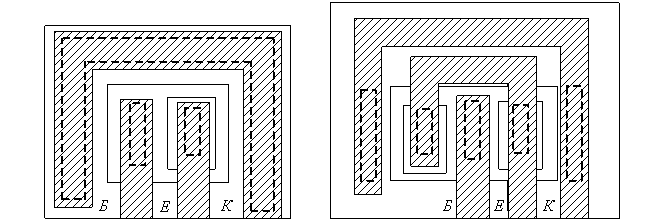
Рисунок 9.7 – Топологія транзистора з П-подібним контактом колектора |
Рисунок 9.8 – Топологія двохемітерного транзистора |
Багатоемітерні транзистори розташовують у вхідних каскадах логічних вентилів з основних на транзисторно-транзисторній логіці. Оскільки контакт до загальної базової області здійснюється за допомогою вузької дифузійної перемички, то інверсний коефіцієнт передачі струму у нього зменшується. Для зменшення опору бази застосовують двобазову конфігурацію транзистора з смуговою конструкцією виводів. Властивості многоемітерної і багатобазової структур поєднуються в гребінчастій конструкції транзистора. Тут Ш-подібні контакти від емітерних і базових областей чергуються, утворюючи дві гребінки, що входять одна в одну своїми зубцями.
Горизонтальні структури транзисторів найбільш широко застосовують для створення транзисторів типу р-n-р. В горизонтальному (латеральному) транзисторі (рис. 9.9) дірки, інжектовані емітером, рухаються до колектора в основному уздовж епітаксійного шару бази, тобто горизонтально. Наявність прихованого n+-шару дозволяє збільшити частину дірок, що досягають колектора, оскільки цей шар служить відбивачем для дірок, що переміщаються перпендикулярно до поверхні кристала. Латеральні транзистори прості в виготовленні, їх застосовують в мікросхемах як складові елементи в складних транзисторних структурах, наприклад, в поєднанні із звичайними планарними транзисторами р-n-р, і рідше – як самостійні елементи. Коефіцієнт передачі струму у латеральних транзисторів малий, частотний діапазон низький.

Рисунок 9.9 – Структура горизонтального латерального р-n-р транзистора
При виготовленні біполярних транзисторів на ізолюючих підкладках, зокрема на КНС-структурах, внаслідок малої товщини епітаксійного шару (0,5 – 1,0 мкм) дифузія домішок відбувається на всю глибину шару і в ньому утворюється структура з вертикальними р-n-переходами, площина яких перпендикулярна до поверхні шару і підкладки. Ширше застосовують вертикальні переходи в МДН-транзисторах.
Ізоляція елементів в ІМС. Для створення ізольованих областей в напівпровідникових мікросхемах використовують обернене зміщення р-n-переходу, покриття з діелектрика, комбінацію обернено зміщених переходів з діелектриком і ізоляцію повітряними проміжками.
Ізоляція обернено зміщеними переходами заснована на дифузії. Великим її недоліком є наявність струму витоку і ємності переходу, а також комутація схеми таким чином, що ізолюючі р-n-переходи завжди знаходяться під зворотним зсувом. Завдяки значному зниженню питомої ємності, високій пробивній напрузі діелектрична ізоляція забезпечує широкі можливості при виготовленні ІМС. Ізоляція діелектриком полягає в тому, що між областями напівпроводникового матеріалу розміщують діелектричний шар. Найбільш розповсюдженим способом ізоляції є епік- процесс. Початковою структурою для нього служить пластина кремнію n-типу, на якій вирощений епітаксійний ![]() -шар. Епітаксійний шар оксидують і в діоксиді кремнію за допомогою фотолітографії розкривають вікна потрібної конфігурації. У вікнах кремній витравляють хімічним методом на глибину 20-30 мкм при ширині розділової канавки 50-80 мкм. На поверхні епітаксійного шару і витравлених канавок шляхом термічного або піролітичного оксидування створюють шар
-шар. Епітаксійний шар оксидують і в діоксиді кремнію за допомогою фотолітографії розкривають вікна потрібної конфігурації. У вікнах кремній витравляють хімічним методом на глибину 20-30 мкм при ширині розділової канавки 50-80 мкм. На поверхні епітаксійного шару і витравлених канавок шляхом термічного або піролітичного оксидування створюють шар ![]() товщиною близько
товщиною близько
1 мкм. Потім на всю поверхню пластини нарощують полікристалічний кремній. Товщина його складає 200-250 мкм, тому всі канавки повністю заростають. На прецизійному полірувальному верстаті частину полікремнію зшліфовують, забезпечуючи плоскопаралелність пластини. Пластину перевертають і шліфують монокристалічну підкладку до тих пір, поки не оголяться канавки, заповнені полікремнієм. Поверхню ретельно полірують і окисляють. Тепер підкладкою структури, по суті, є полікремній. В нього вкраплені окремі ділянки монокристалічного кремнію, ізольовані один від одного плівкою SiO2 і полікремнієм.
Метод позитивної ізоляції, названий за типом вживаного фотошаблона, дозволяє одержувати n-шар з точно заданою товщиною і високою однорідністю. Початковою структурою служить n+ -підкладка з плівкою діоксиду. На неї нарощують полікремній і доводять товщину n+ -підкладки до 8-10 мкм. На цей шар нарощують епітаксійний кремній n-типу заданої товщини до опори. Кремній оксидують і витравляють розділові канавки до полікремнія. Стінки канавок оксидують, після чого всю поверхню структур покривають полікремнієм, який заповнює канавки на всю глибину. Надлишки полікремнія зшліфовують до оголення поверхневого оксиду. Діоксид розчиняють і на структурі проводять планарний процес для створення мікросхеми.
Метод повторного нанесення полікремнію поєднує прийоми епік-процесу і позитивного методу з двократним нанесенням полікремнію. Окислену епітаксійну ![]() структуру покривають полікремниєм. Підкладку зшліфовують на велику глибину, щоб
структуру покривають полікремниєм. Підкладку зшліфовують на велику глибину, щоб ![]() -область була одного порядку товщини з n-областю. Після оксидування селективним травленням створюють канавки до поверхні розділу між кристалом і полікремнієм. Канавки оксидують і наносять на цю сторону пластини другий шар полікремнію великої товщини. Перший шар полікремнію видаляють, створюючи структури, аналогічні структурам, одержаним позитивним методом.
-область була одного порядку товщини з n-областю. Після оксидування селективним травленням створюють канавки до поверхні розділу між кристалом і полікремнієм. Канавки оксидують і наносять на цю сторону пластини другий шар полікремнію великої товщини. Перший шар полікремнію видаляють, створюючи структури, аналогічні структурам, одержаним позитивним методом.
Розглянуті методи включають прецизійне механічне оброблення, яке ускладнюється через прогинання підкладки в результаті відмінності ТКР кремнію і полікремнію, а також різних значень мікротвердості цих матеріалів і діоксиду кремнію. Тому виникли комбіновані методи, зокрема ізопланарний. Ізопланарний метод заснований на застосуванні як ізоляції термічно вирощеного діоксиду кремнію. Після формування в пластині прихованих колекторних областей ![]() -типу на всій поверхні пластини вирощують тонкий епітаксійний n-шар. На ньому формують маску з нітриду кремнію і проводять тривале термічне оксидування кремнію для утворення ізолюючих областей на тих ділянках, де в нітриді кремнію були розкриті вікна. Потім нітрид видаляють, наносять плівку
-типу на всій поверхні пластини вирощують тонкий епітаксійний n-шар. На ньому формують маску з нітриду кремнію і проводять тривале термічне оксидування кремнію для утворення ізолюючих областей на тих ділянках, де в нітриді кремнію були розкриті вікна. Потім нітрид видаляють, наносять плівку ![]() і формують елементи мікросхеми (рис.9.10, а). Для підвищення густини розміщення елементів використовують поліпланарний метод ізоляції, заснований на тому, що вертикальне анізотропне травлення в площині (100). Травлення в цій площині відбувається в 30 разів швидше, ніж в площині (111). Одержані таким чином V–подібні канавки економлять площу, необхідну для ізоляції елементів (рис.9.10, б). Подальше оброблення полягає в заповненні канавок полікремнієм у виготовленні розводки.
і формують елементи мікросхеми (рис.9.10, а). Для підвищення густини розміщення елементів використовують поліпланарний метод ізоляції, заснований на тому, що вертикальне анізотропне травлення в площині (100). Травлення в цій площині відбувається в 30 разів швидше, ніж в площині (111). Одержані таким чином V–подібні канавки економлять площу, необхідну для ізоляції елементів (рис.9.10, б). Подальше оброблення полягає в заповненні канавок полікремнієм у виготовленні розводки.
Не дивлячись на переваги методів діелектричної табуляції, завжди є побоювання пошкодження плівки діелектрика і виникнення паразитного зв'язку через шар полікремнію. З цієї точки зору методи повітряної ізоляції є майже ідеальними. Вони засновані на витравленні окремих острівців кремнію, які з'єднуються один з одним за допомогою комутуючої металізації. Ізоляція повітряним проміжком застосовується в технології балочних виводів, декаль-методі і технології структур кремній на сапфірі (КНС-технології).
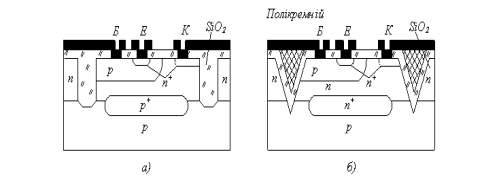
Рисунок 9.10 – Комбініровані методи ізоляції
Технологія балочних виводів застосовується в основному для схем малого ступеня інтеграції. Вона достатньо складна і не забезпечує високої густини розміщень елементів, не дозволяє проводити складну комутацію. Декаль-метод (від слова декалькоманія – нанесення перевідної картинки) полягає в напайці планарної сторони кремнієвої пластини з повністю сформованою мікросхемою на скляну підкладку, видалення протилежної сторони пластини до товщини 20-30 мкм і хімічному витравленні повітряних проміжків навкруги кожного елементу аж до скляної підкладки. Недоліками цього методу є мала густина пакування, поганий тепловідвід і необхідність ретельного узгодження ТКР кремнію і скла.