
А.5.2 Розв'язування
А.5.2.1 а) Оскільки при температурі 1100°С концентрація пі= =6∙1018 см-3, то при легуванні поверхні домішкою з концентрацією
4∙1018см-3 профіль розподілення домішок відповідає процесу "внутрішньої" дифузії:

Тут N0 = 4![]() 1018см-3; t = 3г = 1,08
1018см-3; t = 3г = 1,08![]() 104c; D = 5
104c; D = 5![]() 10-4см2с-1; (Dt)1/ 2= 2,32
10-4см2с-1; (Dt)1/ 2= 2,32![]() 10-5.
10-5.
Тоді 
б) глибину переходу визначаємо з рівняння
 .
.
Згідно з умовою  , звідки хпер=1,39 мкм.
, звідки хпер=1,39 мкм.
А.5.2.2 а) при дифузії атомів бору за гаусівським законом

Значить
![]()

б) тут  . Якщо xпер – глибина переходу, то
. Якщо xпер – глибина переходу, то
 ,
,
звідки  ;
;

А.5.2.3 a)
 ;
;
 ;
;
t = 48,6 хв;
б) знаходимо товщину оксидного шару на вікні з початковою товщиною хі = 20нм:


Знаходимо товщину шару оксиду на попередній плівці при хі = =200нм:

хок= 312 нм.
А.5.2.4
1. Вихідний стан.
2. Епітаксійне нарощування шару п-типу з товщиною 0,254 нм та питомим опором 0,5 Ом∙см:
3. Нарощування шару SiO2 товщиною 500 нм на епітаксійний шар.
4. Накладка фоторезисту, маскування і витравлення вікон в шарі.
5. Легування акцепторною домішкою шляхом дифузії атомів бору.
6. Нарощування шару SiO2.
7. Повторення операції 4 для підготування базової області.
8. Дифузія бору в базову область.
9. Нарощування шару SiO2.
10. Повторення операції 4 для підготування областей емітера і колектора.
11. Дифузія донорної домішки.
12. Нарощування шару SiO2.
13. Повторення операції 4 для утворення вікон під контактні площадки.
14. Металізація всієї поверхні вакуумним розпиленням алюмінію.
15. Повторення операції 4 для утворення міжз'єднань. Видалення залишків алюмінієвого шару.
16. Контроль функціонування.
17. Вміщення у корпус.
18. Вихідний контроль.
А.5.2.5 а)




5.2.6 а) для кожної схеми концентрація носіїв у базі визначається із формули:

б) в схемі 1

В схемі 2

В схемі 3

в) в схемі 2 струм ІБ дуже малий, тому що тут транзистор працює в активному режимі, і напруга на переході база-емітер мала;
г) всі три рівняння для струму ІF, які отримані в п. б) мають співмножники однакового виду. Якщо вважати, що DпБ∙DрК∙DрЕ і LрК∙LрЕ , то для розрахунку відносних концентрацій неосновних носіїв у базі для кожного випадку можна використовувати приблизні вирази, які стоять у дужках, і отримати

![]()

Як наслідок, загальний накопичений заряд в схемі 2 виходить суттєво меншим, ніж в схемах; 1 і 3. Напруга пробою Uпроб в схемі 3 найбільша, тому що тут під напругою буде перехід база-колектор, в схемах 1 і 2 напруга прикладена до переходу база-емітер;
д) згідно з рівнянням Еберса-Молла
![]()
В схемі 1
 де використана рівність
де використана рівність ![]()
В схемі 2 напруга UКБ = 0, тому

В схемі 3 напруга UЕБ = 0, UКБ = U, тому ![]()
Оскільки ![]() , то струм в схемі 1 при одній і тій же напрузі U
, то струм в схемі 1 при одній і тій же напрузі U
буде найбільшим, однак, якщо ![]() , то в схемі 3 струм буде практично таким же.
, то в схемі 3 струм буде практично таким же.
А.5.2.7 

![]()
![]()
Оскільки транзистор VT1, за міркуванням, працює в насиченому режимі під час розрядки, то 
Транзистор VT2 насичений під час зарядки, що визначається граничними точками Uвих = 0, UКБ = 5 В, тому

А.5.2.8 Якщо до затвора приладу прикласти напругу UЗ > 0, то в шарах товщиною х1і х2 виникають електричні поля, напруженості яких зв'язані між собою законом Гаусса :
![]() ,
,
де Q – заряд накопичений у плаваючому затворі.
Крім того UЗ=Е1 х1+Е2 х2.


![]() .
.
а) якщо накопичений заряд не знижує суттєво напруженість поля Е, тобто у випадку, коли ![]() ,
,


б) якщо ![]() ,
, ![]() , то
, то
![]()

А.5.2.9 а) максимальна концентрація

б) 

 ;
;
 ;
;  ;
;
х=2∙1,772∙(2,75∙10-12∙2,16∙104)1/2=8,64 мкм.
![]() .
.
А.5.2.10
а) 




хd2=10,95 мкм;
б) уявимо, що 1016 електронів вводиться у другий електрод, при цьому
![]()


Можна бачити, що ![]() . Тому 1016 електронів залишаються в околі другого електрода.
. Тому 1016 електронів залишаються в околі другого електрода.

А.5.3 Задачі
А.5.3.1 Здійснюється дифузія крізь епітаксійний шар товщиною 10мкм, в результаті якої повинна забезпечуватися концентрація донорів 1016см-3. Концентрація дифундованої речовини на поверхні складає 5∙1019см-3 і підтримується постійною в ході процесу. Визначити тривалість операції при температурі в печі 1200°С, якщо коефіцієнт дифузії ![]() = 3∙10-12 см2/с.
= 3∙10-12 см2/с.
Вказівка: з таблиць функції erfc відомо, що при ![]() = 2∙10-4 значення
= 2∙10-4 значення 
А.5.3.2 Кремнієва підкладка легована атомами бору з концентрацією ![]() =1,5∙107 cм-3. На поверхню підкладки нанесений миш'як p концентрацією
=1,5∙107 cм-3. На поверхню підкладки нанесений миш'як p концентрацією ![]() =1,5∙102 cм-3. Процес здійснюється тривалістю 20 хвилин при температурі 1200◦С, коефіцієнт дифузії
=1,5∙102 cм-3. Процес здійснюється тривалістю 20 хвилин при температурі 1200◦С, коефіцієнт дифузії ![]() = 2,46∙10-13 см2/с. Визначити глибину переходу хпер.
= 2,46∙10-13 см2/с. Визначити глибину переходу хпер.
Вказівка: при  , використовуючи функцію erfc, маємо рівність
, використовуючи функцію erfc, маємо рівність ![]() = 2,73.
= 2,73.
А.5.3.3 На кремнієвій підкладці р-типу створений епітаксійний шар п-типу товщиною 10мкм з концентрацією 1016см-3. Для ізоляції п-шару проводять дифузію бору при температурі 1200°С. Коефіцієнт дифузії ![]() = = 2,5∙10-12 см2/с; концентрація бору на поверхні постійна і складає 1020 см-3. а) яка повинна бути тривалість даного процесу? При відповіді використайте те, що рівняння erfc(z) = 10-4 має корінь z
≈ 2,75. б) на яку глибину продифундуються атоми сурми, що утворюють прихований домішковий шар, в дану епітаксійну плівку за визначений в п. а) час? Коефіцієнт дифузії
= = 2,5∙10-12 см2/с; концентрація бору на поверхні постійна і складає 1020 см-3. а) яка повинна бути тривалість даного процесу? При відповіді використайте те, що рівняння erfc(z) = 10-4 має корінь z
≈ 2,75. б) на яку глибину продифундуються атоми сурми, що утворюють прихований домішковий шар, в дану епітаксійну плівку за визначений в п. а) час? Коефіцієнт дифузії ![]() =2∙10-13 см2/с; незмінна концентрація домішки на межі системи підкладка-епітаксійний шар дорівнює 1020см-3.
=2∙10-13 см2/с; незмінна концентрація домішки на межі системи підкладка-епітаксійний шар дорівнює 1020см-3.
А.5.3.4 Епітаксійний шар товщиною 10мкм рівномірно легований донорною домішкою з концентрацією 5∙1015см-3. Щоб ізолювати цей шар, проводять дифузію атомів бору, які нанесені на поверхню з концентрацією 1019см-3. Процес триває 10 годин, під час якого концентрація домішки на поверхні підтримується постійною. Визначити температуру, яку необхідно створити в печі.
Вказівка: відомо, якщо  , то коефіцієнт дифузії
, то коефіцієнт дифузії
![]() =1,138
=1,138![]() 10-12 см2/с одержимо при 1000/Т = 0,7.
10-12 см2/с одержимо при 1000/Т = 0,7.
А.5.3.5 Базова область біполярного транзистора сформована дво-етапною дифузією бору, яка забезпечує гаусівський профіль розподілу домішок. Відомо, шо на поверхні концентрація домішки 8∙1017см-3, глибина емітерного переходу 1,3мкм, глибина колекторного переходу 2 мкм, концентрація домішки в епітаксійному колекторному шарі 1015см-3. Знайти вираз, який описує розподіл концентрації легуючої домішки в базі.
А.5.3.6 Знайти час, який необхідний для нанесення оксидного шару товщиною 450нм при температурі 1050°С. На поверхню пластини з кремнію р-типу питомим опором 10 Ом∙м. Процес оксидування вологий і характеризується параметрами А = 0,31 мкм; В = 0,47мкм2/год.
А.5.3.7 Поверхня кремнієвої пластини вкрита оксидним шаром товщиною 100нм. Визначити час, який необхідний для створення додаткового шару оксиду в атмосфері сухого оксигену при температурі 1200°С. Остаточна товщина шару хок = 0,18 мкм достатня для маскування дифузії бору, що здійснюється за 100 хвилин при температурі 1100°С. Константи оксидування при температурі 1200°С А = 5∙102 мкм; В = 4,2∙10-2 мкм2/год.
А.5.3.8 Знайти час, за який формується оксидна плівка товщиною 2мкм на поверхні кремнієвої підкладки при температурі 960°С і тиску пари 25атм (2,45МПа). Константи оксидування при таких умовах: А=0,50 мкм; В = 5,0 мкм2/год.
А.5.3.9 Горизонтальний п+-р-перехід створений шляхом дифузії фосфору в кремнієву підкладку р-типу. Потім перехід піддано сухому оксидуванню при температурі 900°С терміном 5год. Відомо, що початкова товщина оксидної плівки перед сухим оксидуванням над п+ - складає 2мкм, а над р-областю на 0,054 мкм більша. При заданих умовах константи оксидування мають значення А = 2,25∙102 мкм; В = 5,4∙10-3 мкм2/год. Визначити різницю товщин оксидних шарів над п+ - і р-областями.
А.5.3.10 Плівковий резистор ІС створений дифузією атомів фосфору в епітаксійний шар р-типу, легований з концентрацією ![]() = 1017см-3. Після перерозподілу домішок при температурі 1000
°С глибина р-п-переходу хпер = = 2,5 мкм. Визначити поверхневий опір шару плівки (Ом/cм ), отриманий в процесі дифузії, якщо відповідна питома провідність
= 1017см-3. Після перерозподілу домішок при температурі 1000
°С глибина р-п-переходу хпер = = 2,5 мкм. Визначити поверхневий опір шару плівки (Ом/cм ), отриманий в процесі дифузії, якщо відповідна питома провідність ![]() = 1,5∙103 См/см. Знайти довжину резистора опором 2 кОм, якщо його мінімальна ширина має 6,1∙10-3мкм.
= 1,5∙103 См/см. Знайти довжину резистора опором 2 кОм, якщо його мінімальна ширина має 6,1∙10-3мкм.
А.5.3.11 Відносна діелектрична проникність матеріалів SіO2 і SiN4 дорівнює 3,9 і 7,5, відповідно. Визначити для кожного випадку питому ємність (Ф/см2) шару матеріалу товщиною 0,1мкм.
А.5.3.12 На кремнієвій підкладці р-типу з параметрами ![]() = 20 Ом∙см;
= 20 Ом∙см; ![]() = 500 см2В-1с-1 створена ізольована епітаксійна область п-типу, яка має питомий опір 0,2 Ом∙см, довжину 0,254 мм, ширину 0,127 мм і товщину 0,0254 мм. Знайти паразитну ємність між п-областю і підкладкою р-типу, якщо до області прикладено зворотну напругу 5В. Ємність складається з ємності С1 між областю і підкладкою, а також ємності С2, яка обумовлена бічними ділянками, причому питома ємність складає 0,1пФ/0,000645 мм2.
= 500 см2В-1с-1 створена ізольована епітаксійна область п-типу, яка має питомий опір 0,2 Ом∙см, довжину 0,254 мм, ширину 0,127 мм і товщину 0,0254 мм. Знайти паразитну ємність між п-областю і підкладкою р-типу, якщо до області прикладено зворотну напругу 5В. Ємність складається з ємності С1 між областю і підкладкою, а також ємності С2, яка обумовлена бічними ділянками, причому питома ємність складає 0,1пФ/0,000645 мм2.
А.5.3.13 В інтегральній схемі сформований МОН-конденсатор з товщиною оксидною шару 50 нм. Знайти площу, яку цей конденсатор займає на кристалі, якщо його ємність 200 пФ. Вважати, що ![]() = 3,5.
= 3,5.
А.5.3.14 Скласти список не менше 15 операцій, починаючи з нанесення шару SiO2 і закінчуючи металізацією алюмінієм, які входять у технологічний цикл виробництва епітаксійного транзистора з подвійною дифузією і з прихованим шаром.
А.5.3.15 Визначити кількість фотошаблонів і мету їх використання, необхідних для створення п-р-п-транзисторів інтегральних схем при одному шарі внутрішньо-схемних з'єднань за технологією: а) епітаксійно-планарною: б) ізопланарною.
А.5.3.16 Які параметри епітаксійно-планарного транзистора ІС з прихованим шаром зміняться, якщо: а) зменшити горизонтальні розміри прихованого п+-шару; б) зменшити концентрацію домішок в цьому шарі; в) збільшити горизонтальні розміри цього шару так, щоб він досягав ізолювальних р-областей; г) використовувати фосфор, як легуючу домішку в цьому шарі?
А.5.3.17 Які параметри ізопланарного п-р-п транзистора ІС зміняться, якщо: а) при незмінній товщині бази зменшити товщину епітаксійного шару настільки, що база буде межувати з прихованим п-переходом; б) збільшити енергію іонів при легуванні бази; в) зменшити дозу легування бази?
А.5.3.18 В скільки разів зміниться надмірний заряд дірок в колекторі п-р-п транзистора при використанні у його структурі переходу Шотткі між колектором і базою, якщо різниця спаду напруг на колекторі відносно аналогічного транзистора без цього переходу U = 260 мВ при температурі Т = 120 оС ?
А.5.3.19 а) Нарисувати принципові схеми п'яти основних варіантів реалізації діода на основі п-р-п-транзистора: колектор з'єднаний з базою, колектор з'єднаний з емітером, колектор вільний, емітер з'єднаний з базою, емітер вільний; б) вияснити, у якої з цих схем найменший спад напруги при прямому зміщенні; в) у якої з схем напруга пробою найбільша; г) у яких схемах найбільші і найменші зворотні струми?
А.5.3.20 Якщо не виконати відповідних заходів, то при виникненні контакту алюмінію з кремнієм в колекторній області п-р-п-транзистора утворюється не омічний контакт, а діод Шотткі. Пояснити, яку технологічну операцію необхідно провести, щоб на межі поділу Al-Si утворився омічний контакт.
А.5.3.21 Пояснити, чому транзистору р-п-р з горизонтальною структурою притаманні низькі значення параметра β ?
А.5.3.22 На деякій підкладці (П) створений транзистор VT1 типу п-р-п: а) нарисувати, яким чином між чотирма виводами Е, Б, К і П розташовуються транзистор VT1 разом з транзистором VT2 типу р-п-р; б) використовуючи рисунок, пояснити в якому режимі працює транзистор VT2, якщо транзистор VT1 перебуває: 1) в активному режимі; 2) в режимі відсічки: 3) в режимі насичення.
А.5.3.23 Часто в ІС використовують багатоемітерні біполярні транзистори типу п-р-п. а) у чому причина їх широкого використання; б) як зміниться інверсний коефіцієнт передачі багатоемітерного транзистора при зменшенні струму бази?
А.5.3.24 Знайдіть опір і паразитну ємність резистора, створеного в базовому шарі біполярного п-р-п-транзистора товщиною 0,2 мкм, довжиною l = 100мкм і шириною b = 5мкм, ![]() = 1013см-3;
= 1013см-3; ![]() = 300 см2В-1с-1. Концентрація донорів у епітаксійному шарі
= 300 см2В-1с-1. Концентрація донорів у епітаксійному шарі ![]() = 1016см-3, напруга на кінцях резистора відносно підкладки U1 = 260мВ, U2 = 260мВ, UП = 260мВ. Ємністю і опором крайових (контактних) областей можна знехтувати. Вказівка: для розрахунку паразитної ємності використати формулу для бар'єрної ємності плоского р-п-переходу iз ступінчатам розподілом домішок.
= 1016см-3, напруга на кінцях резистора відносно підкладки U1 = 260мВ, U2 = 260мВ, UП = 260мВ. Ємністю і опором крайових (контактних) областей можна знехтувати. Вказівка: для розрахунку паразитної ємності використати формулу для бар'єрної ємності плоского р-п-переходу iз ступінчатам розподілом домішок.
А.5.3.25 Знайти максимальну ємність тонкоплівкового конденсатора з діелектриком із SiO і розмірами верхньої обкладки 100x100мкм при напрузі пробою 30В, відносна діелектрична проникність монооксиду кремнію ![]() = 5.
= 5.
А.5.3.26 Затвор польового транзистора типу р-МОН, який працює в режимі збагачення, з'єднаний зі стоком: а) нарисувати відповідну принципову схему; б) знайти вид функції ІС = f(UС).
А.5.3.27 Рівняння п-МОН-транзнстора, який працює в тріодному (лінійному) режимі, має вигляд ІС = k[(UС - Uпор) UС – U2С] при ![]() . Відповідні рівняння для режиму насичення:
. Відповідні рівняння для режиму насичення:
ІСнас = k(UС- Uпор)2 при ![]() ;
;
постійний коефіцієнт  .
.
Дати зображення вихідної характерники ІС = f(UС) для даного транзистора при UЗ = 2,3 і 4В. Відомо, що k = 1мА/В2; ![]() = 2В.
= 2В.
А.5.3.28 Маємо п-МОН-транзистор, який працює в режимі збагачення:
а) визначити, чому дорівнює напруга UС, якщо затвор з'єднаний із стоком і крім того ІС ≈ 0; б) поясніть, чому при Uзс = 0 прилад насичений незалежно від значення струму ІС .
А.5.3.29 Нарисуйте в одній системі координат залежності напруг пробою і замикання від глибини залягання р-п-переходів в структурі п-канального транзистора (рис. А.5.1).
А.5.3.30 Яка різниця значень питомої крутизни і часу прольоту каналу комплементарних транзисторів з однаковими розмірами в структурі (рис. А.5.2)?
А.5.3.31 Які електричні параметри МДН-транзистора (див. рис. А.5.1) і як вони зміняться, якщо затвор легувати не донорами, а акцепторами?
А.5.3.32 Визначити розкид порогової напруги МДН-транзистора при φмн = 0,8В, Ndk = 1017см-3, якщо товщина каналуd0= 0,2 мкм±10%.
А.5.3.33 Скільки фотошаблонів і для яких цілей необхідно при створенні МДН-транзистора (див. рис. 5.3)?
А.5.3.34 Які параметри найпростішого елемента ТТЛ (див. рис. А.5.7) і як вони змінюються при: а) підвищеній напрузі UЖ ; б) підвищенні температури; в) збільшенні опору R1 (при незмінних R2 і UЖ); г) заміні епітаксійно-планарних транзисторів на ізопланарні; д) вилученні в структурі багатоемітерного транзистора (див. рис. А.5.4) ділянки вузької пасивної бази або шару металізації, що розташовані посередині базової області; е) легування кристалу атомами золота?
А.5.3.35 Визначити: а) вхідні струми найпростішого елемента ТТЛ (див. рис. 5.5) при UЖ = 2,5В, UБЕ = UКЕ = 0,7В, R1 = 2кОм,
β11=0,05 при Uвх=0,2В і Uвх=2,2В; б) як змінюються ці струми при підвищенні температури до 125◦С (![]() ), якщо використовуються напівпровідникові резистори на основі базового шару?
), якщо використовуються напівпровідникові резистори на основі базового шару?
А.5.3.36 Для створення п-МОН-транзистора використана пластина кремнію р-типу з питомим опором 10Ом∙см і орієнтацією (100). Області стоку і витоку утворені імплантацією атомів миш'яку з енергією 80кеВ і дозою 1016іонів/см2. Через оксидний шар товщиною 25нм імплантуються атоми бору з енергією 30кеВ і дозою Ф = 8∙1011іонів/см2. Внаслідок цього біля межі поділу Si-SiO2 виникає шар негативних зарядів. Визначити розкид порогової напруги
ΔUпор в даному приладі, якщо ![]() = 3,9. Припускається, що при енергії 30кеВ Rр
= 3,9. Припускається, що при енергії 30кеВ Rр![]() Rр = 34нм як для Si, так і для SiO2, значення функції
Rр = 34нм як для Si, так і для SiO2, значення функції ![]() . Вказівка: кількість іонів бору в кремнії визначається за формулою:
. Вказівка: кількість іонів бору в кремнії визначається за формулою:

А.5.3.37 Визначити середню (статистичну) потужність, яка розсіюється п-МОН-інвертором (див. рис. А.5.6). Параметри приладів: UЖ=+5В, Uпор1 = = +0,6В; Uпор2 = -2В; ![]() = 700 см2В-1с-1; С0 =7,08∙10-8Ф/см2; b1/l1=4; b2/l2=1/3.
= 700 см2В-1с-1; С0 =7,08∙10-8Ф/см2; b1/l1=4; b2/l2=1/3.
А.5.3.38 Просте електричне коло утворене паралельним з'єднанням транзисторів типу р-МОН; п-МОН: а) дати зображення відповідної принципової схеми; б) вважати, що обидва транзистори працюють в режимі збагачення при UЖ = +5В, Uпор = 2В; k = 1мА/В2, подати в табличній формі зв'язок між струмом і напругою для такого кола, якщо напруга змінюється від 0 до 15В.
А.5.3.39 Для КМОН-інвертора (див. рис. 5.7) знайти і графічно відобразити залежність між напругами на вході і на виході. Врахувати, що UЗ = -17В; UЖ = -5В, Uпор.р = Uпор.п = 2В; k1 = 40k.
А.5.3.40 Маємо деякий прилад із зарядовим зв'язком: а) визначити поверхневий потенціал при UЗ=15В; Q=0; хок = 0,1мкм і ![]() =1015см-3; б) знайти максимальний заряд, який може бути накопичений при умовах вказаних в п. а).
=1015см-3; б) знайти максимальний заряд, який може бути накопичений при умовах вказаних в п. а).
А.5.3.41 Відомо, що двофазний П33 створений на підкладці р-типу з орієнтацією (100), причому ![]() = 1016см-3; Q = 1010∙е = 1,6∙10-9Кл/см2. Затвор з полікристалічного кремнію легований домішкою з концентрацією
= 1016см-3; Q = 1010∙е = 1,6∙10-9Кл/см2. Затвор з полікристалічного кремнію легований домішкою з концентрацією ![]() =1018см-3; і має товщину оксидного шару хок = 50нм. Затвор з алюмінію має товщину оксидного шару хок = 100нм До однієї з доз подано імпульс напруги амплітудою 8В. Визначити: а) скачок напруги, який утворює потенціальну яму; б) максимальний накопичуваний заряд; в) мінімальний заряд, який ще можна визначити, якщо густина струму витоку, що обумовлений поверхневою генерацією складає 1нА/см2, а частота синхронізації – 2МГц. Вихідні дані:
=1018см-3; і має товщину оксидного шару хок = 50нм. Затвор з алюмінію має товщину оксидного шару хок = 100нм До однієї з доз подано імпульс напруги амплітудою 8В. Визначити: а) скачок напруги, який утворює потенціальну яму; б) максимальний накопичуваний заряд; в) мінімальний заряд, який ще можна визначити, якщо густина струму витоку, що обумовлений поверхневою генерацією складає 1нА/см2, а частота синхронізації – 2МГц. Вихідні дані: ![]() = 3,4
= 3,4![]() 10-13Ф/см; еФм(Al) = 4,1еВ; Еg(Si) = 1,12еВ; ni = 1,4∙1010см-3;
10-13Ф/см; еФм(Al) = 4,1еВ; Еg(Si) = 1,12еВ; ni = 1,4∙1010см-3; ![]() = 4,15 еВ;
= 4,15 еВ; ![]() = 1,04∙10-12Ф/см.
= 1,04∙10-12Ф/см.
А.5.3.42 Знайти мінімальний струм, який необхідно забезпечити при запису інформації в елемент пам'яті (див. рис. А.5.8) при І1=10мкА; ![]() ;
; ![]() ;
; ![]() .
.
А.5.3.43 Знайти інформаційний заряд в елементі пам'яті (див. рис. А.5.9) при Uпор1=5В, Uпор2=1В; товщина шару SiO2 між затворами 4 і 3, а також затвором 4 і підкладкою дорівнює 0,05мкм.
А.5.3.44 Аналогова лінія затримки вміщує трифазний П33, що має 1000 комірок, і працює при тактовій частоті 1Мгц. Коефіцієнт затухання, що припадає на 1 комірку, дорівнює 10-4. Визначити затухання і фазовий зсув сингалу на частоті 10кГц і на третій гармоніці цієї частоти. Вказівка: якщо f – частота сигналу на вході, то амплітуда сигналу на виході П33 визначасться за формулою:

де Ап – амплітуда сигналу після проходження т ступенів (п=3т); А0 – початкова амплітуда пакета заряду; kзат – коефіцієнт затухання ; fc – частота синхронізації. Фазовий зсув 
А.5.3.45 Запам'ятовувальний пристрій на базі двофазного ПЗЗ має електроди з однаковою довжиною і шириною 8мкм. Відстань між ними також дорівнює 8мкм: а) знайти площину, яку займає комірка пам'яті, яка складається з двох електродів; б) відомо, що пристрій пам'яті ємністю 64 кБ (65536 біт) розташовано на кристалі площею 5,54∙5,97мм. Визначити яку частину площі кристала займають допоміжні кола (синхронізації, елемент узгодження тощо).
А.5.3.46 Згідно з ПЗЗ, розглянутого у вправі А.5.1.10, на основі отриманих раніше результатів знайти: а) напруженість електричного поля розсіювання, якщо відстань між сусідніми електродами складає 3 мкм; б) час розповсюдження зарядів під дією поля розсіювання, якщо кожному електроду відповідає потенціальна яма глибиною UЗ=20В. Вважати, що в початковому стані 106 електронів рівномірно заповнюють потенціальну яму глибиною UЗ=10В. Відомо, що рухливість електронів на поверхні ![]() = = 650 см2В-1с-1. Вказівка: час розповсюдження
= = 650 см2В-1с-1. Вказівка: час розповсюдження  .
.
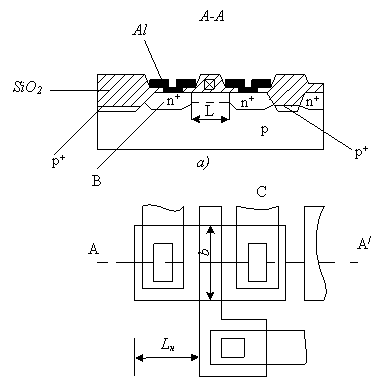
б)
Рисунок А.5.1
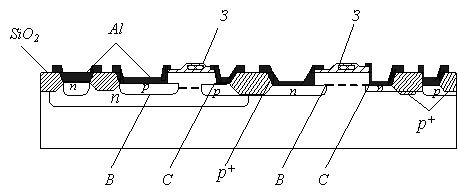
Рисунок А.5.2
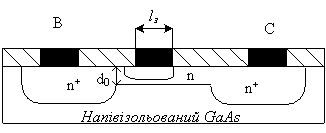
Рисунок А.5.3
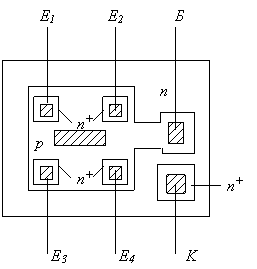
Рисунок А.5.4
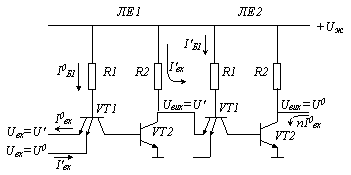
Рисунок А.5.5
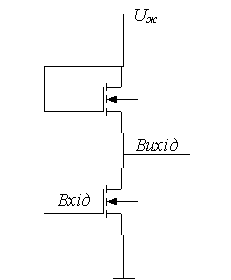
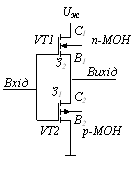
Рисунок А.5.6 Рисунок А.5.7
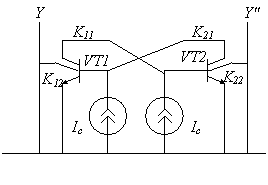
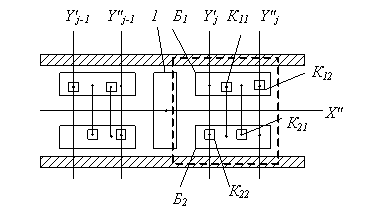
Рисунок А.5.8
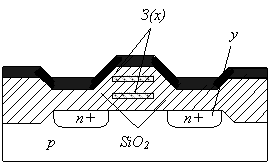

Рисунок А.5.9